手头的问题并不是一个新问题:晶体管功耗的缩小速率险些没有晶体管尺寸那么快。由于芯片制造商不会放弃性能(并且无法为客户供应半年增长),因此在 HPC 空间中,每个晶体管的功率正在迅速增长。另一个问题是,chiplet正在为构建具有比传统标线限定更多硅的芯片铺平道路,这对性能和延迟有好处,但在冷却方面更成问题。
支持这种硅和功率增长的是 台积电 CoWoS 和 InFO等当代技能,它们许可芯片制造商构建集成的多芯片系统级封装 (SiP),其硅量是台积电的两倍。受到标线(reticle )限定。到 2024 年,台积电 CoWoS 封装技能的进步将使构建更大的多芯片 SiP 成为可能,台积电估量将超过四个标线大小的芯片缝合在一起,这将实现巨大的繁芜性(每个 SiP 有可能超过 3000 亿个晶体管)台积电及其互助伙伴正在关注)和性能,但自然因此巨大的功耗和发热为代价的。

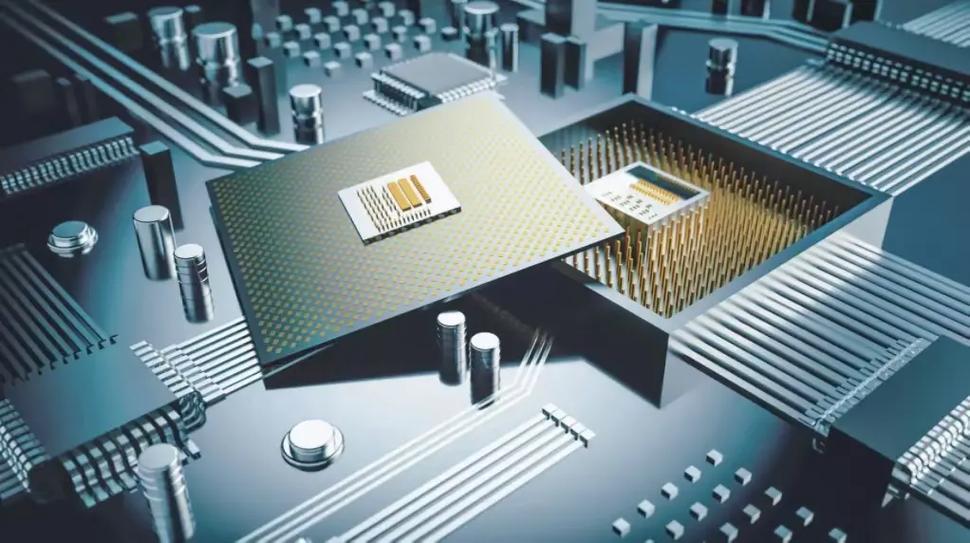
NVIDIA 的 H100 加速器模块等旗舰产品已经须要超过 700W 的功率才能实现峰值性能。因此,在单个产品上利用多个 GH100 大小的chiplet的前景令人大跌眼镜 - 以及功率预算。台积电估量,几年后将涌现功耗约为 1000W 乃至更高的多芯片 SiP,从而带来冷却寻衅。
在 700W 时,H100 已经须要液冷;英特尔的基于chiplet的 Ponte Vecchio 和 AMD 的 Instinct MI250X 的故事大致相同。但纵然是传统的液体冷却也有其局限性。当芯片累计达到 1 kW 时,台积电设想数据中央将须要为这种极度的 AI 和 HPC 处理器利用浸入式液体冷却系统。反过来,浸入式液体冷却将须要重新构建数据中央本身,这将是设计上的重大变革,也是连续性方面的重大寻衅。
撇开短期寻衅不谈,一旦数据中央设置为浸入式液体冷却,它们将为更热的芯片做好准备。液浸式冷却在处理大型冷却负载方面具有很大潜力,这也是英特尔大力投资这项技能以使其更加主流化的缘故原由之一。
除了浸没式液体冷却,还有另一种技能可以用来冷却超热芯片——片上水冷。去年,台积电透露它已经考试测验过片上水冷,并表示乃至可以利用这种技能冷却 2.6 kW 的 SiP。但当然,片上水冷本身便是一项极其昂贵的技能,它将把那些极度的 AI 和 HPC 办理方案的本钱推到前所未有的水平。
只管如此,虽然未来不是一成不变的,但彷佛它已经用硅铸造了。台积电的芯片制造客户有客户乐意为这些超高性能办理方案(想想超大规模云数据中央的运营商)支付高昂的用度,纵然这须要高本钱和技能繁芜性。让事情回到我们开始的地方,这便是台积电首先开拓 CoWoS 和 InFO 封装工艺的缘故原由——由于有客户准备好并渴望通过chiplet技能冲破标线限定。本日,我们已经在 Cerebras 的大型晶圆级引擎处理器等产品中看到了个中的一些,并且通过大型小芯片,台积电正准备让更广泛的客户群更随意马虎得到更小的(但仍旧是标线断裂)设计。
对性能、封装和冷却的这种极度哀求不仅将半导体、做事器和冷却系统的生产商推向了极限,而且还须要对云数据中央进行修正。如果用于 AI 和 HPC 事情负载的大规模 SiP 确实变得普遍,那么未来几年云数据中央将完备不同。
★ 点击文末【阅读原文】,可查看本文原文链接!
欢迎订阅摩尔精英旗下更多公众年夜众号:摩尔精英、半导体行业不雅观察、摩尔App\公众 data-from=\"大众0\"大众>
免责声明:本文由作者原创。文章内容系作者个人不雅观点,半导体行业不雅观察转载仅为了传达一种不同的不雅观点,不代表半导体行业不雅观察对该不雅观点赞许或支持,如果有任何异议,欢迎联系半导体行业不雅观察。
本日是《半导体行业不雅观察》为您分享的第3084内容,欢迎关注。
晶圆|集成电路|设备|汽车芯片|存储|台积电|AI|封装
















