张磊 王健
(中国电子科技集团公司第五十四研究所)

择要:
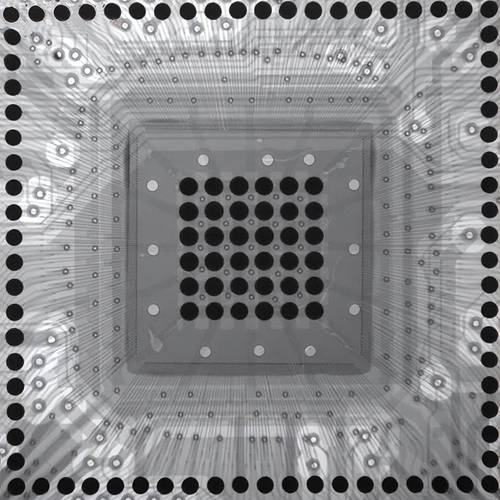
封装是集成电路设计流程中非常主要的一环,是管芯的环境载体,供应了信息交互、电源供给、散热与构造强度。随着集成电路工艺发展,管脚数目越来越多、频率逐年翻番,只有采取管脚集成度更高、速率更快的倒装焊封装技能,才能知足设计哀求。本文从版图布局开始,对重布线层设计、柱下金属层的加工、基板设计,以及与流片厂商、封装厂商数据交互,进行了归纳总结,为对倒装焊封装设计有需求的项目供应了参考见地,具有一定借鉴意义。
1 媒介
封装是将芯片的“裸芯”通过膜技能及微细加工技能,固定在框架或基板上,完成粘贴及连接,通过引出接线端子,完成对外的电器互联。随着集成电路家当的发展,流片加工工艺越来越前辈,单片集成度越来越高,引出端数目也越来越多,传统四周排布 PAD 的办法,无论是 in-line 或是stagger,都可能无法知足间隔哀求。同时,很多大规模电路功耗较大、所集成的外设速率越来越高,例如高速 SERDES 接口,传输速率高达 12.5GHz,致使传统的引线键合(wire bond)封装技能,由金线带来的寄生参数无法知足设计指标求,从而必须采取倒装焊封装技能手段,来知足较多的引出端数目、较大的供电能力,以及超高的速率哀求。wire bond 封装和倒装焊封装的差异,一是,前者引出端为四周引出办法,倒装焊封装的引出端为内部二维矩阵排布,二者的封装键合图如图 1 所示。
二是,倒装焊封装由四周排布扩展至二维矩阵排布,从而使得引出端数量大幅增加,理论引出端数量比拟见表 1。
本文所选取的超大规模集成电路芯片,集成了12.5Gbps 高速 Serdes 硬核,DDR 硬核,LVDS 接口,以及业务处理所需的数据接口。实现工艺为中芯国际(SMIC)65nm,面积达到了 7000 mm×7500mm,管芯引出端数量靠近 700 个,封装形式为 CBGA272。
由于全体芯片封装过程中,须要物理版图工程师、Foundry 工程师,与封装厂商三部分高度协同设计。不同身份的设计师,在数据交互时,各自理解不同,随意马虎产生事情冗余迭代,影响效率。以是,本文将芯片封装过程所涉及的事情内容进行了梳理,展开来进行阐述。
2 管芯设计内容
此章节紧张事情由物理版图设计师完成,针对倒装焊设计与传统引线键合设计的差异进行了阐述。
2.1 版图布局设计
如图 2 所示,倒装焊封装的 IO 虽然是二维矩阵式(area-IO)排布,但须要把稳的是在物理设计时,引出端可以依旧选择四周排布的办法(peripheral-IO)。
例如本芯片集成的 Serdes 核为硬核形式,IP 设计师给出了图形信息以供走线互连。其他部分的 IO将按照传统布局办法进行连接。
其余,由于本芯片功耗未超过 1W,压降效果不明显,故无需像 FPGA 管芯的设计,从内部做垂直形状的 IO。
2.2 重布线层设计
重布线层(RDL,Redistribute Layer)。其为倒装焊设计独占的层,用来对管芯引脚重新走线,最大化的增加引出端数量。在 SMIC 65nm 加工工艺中,重布线层的掩膜板层命名见表 2。
在设计时,须要参考 SMIC 的设计规则,紧张规则如表 3 和图 3 所示。
表 3 显示了详细规则数值。例如 RDL 布线间距(trace space)不得小于 12um,每个 bump 间距(bump pitch)不得小于 150um 等等规则。
本芯片的目标设计时,结合 BGA272 的封装形式,其 RDL 层布线如图 4 所示。
完成了全体重布线层版图设计,形成了终极的GDSII 文件,就可以提互换片数据。
2.3 版图数据提交
图 5 显示了版图工具中翻转、镜像的设置界面,基此,单颗管芯设计完成后,要提交的版图数据包括:一是须要整理出整颗管芯的尺寸,每个引出真个坐标,是否预留了划片道等信息。二是将该信息交付到流片工程师,完成整版的拼版,此时须要把稳的是倒装焊由于是“倒装”的焊接到基板上,须要特殊把稳是否存在版图镜像、翻转的操作。
3 封装设计内容
3.1 封装信息交互
当完成了目标的 RDL 设计之后,就可以提互换片厂商进行 Wafer 的加工生产了,并进行干系封装信息交互。流片厂商会反馈各种信息,个中有些是须要供应给后道封装的。包括晶片初始厚度、目标减薄厚度,划片道宽度、焊盘尺寸与开口尺寸等信息。
3.2 UBM 层制作把稳事变
凸块底部金属(UBM)层一样平常为第三方加工厂制作,须要基于整张 Wafer 进行 MASK 设计,须要精度较高的 Floorplan 图(见图 6),以及倒装焊目标芯片的 IO 坐标。将在版图中丈量出的间距信息供应至UBM 厂商,完成 0.01um 级别精度的 MASK 制作。
3.3 基板及外壳制作内容
图 7 是基板走线示意图,从中看出,基板(sub- strate)设计,与高速 PCB 设计规则类似,紧张须要考虑电地及旗子暗记的走线,避免串扰,尽可能的降落层数,以便节省本钱。
完成了基板设计,如图 8 所示,要结合封装形式进行仿真。
3.4 封装芯片成品
终极完成封装形式为 CBGA272 的倒装焊封装的芯片实物(见图 9),完成了 bump 植柱,未植焊接球。
4 总结及展望
毫无疑问,技能没有前辈和掉队一分,只有是否适用于当前产品。倒装焊封装设计繁芜度较高,带来了更长的设计周期,增加了研发本钱;加工步骤的增多,带来了生产本钱的增加;前辈的片内封装技能,例如 UBM、基板,都须要进行锡料焊接,虚焊等成分导致良率降落,并且测试排查手段只能通过 X 光进行不雅观测,反馈迭代周期、本钱都较长。
当决定采取倒装焊封装后,每个环节的衔接交互都须要格外谨慎,保障芯片终极达到设计目标。
















