(图片来源:网络)
第一阶段

20世纪70年代是通孔插装时期,以双列直插封装(DIP)为代表,DIP适宜在印刷电路板上穿孔焊接,操作方便。在衡量一个芯片封装技能是否前辈的主要指标是芯片面积和封装面积之比越靠近于1,这种封装技能越前辈。DIP封装由于芯片面积和封装面积之比相差大,故封装完成后体积也比较大,因此在无法知足小型化等哀求的情形下而逐步被淘汰。
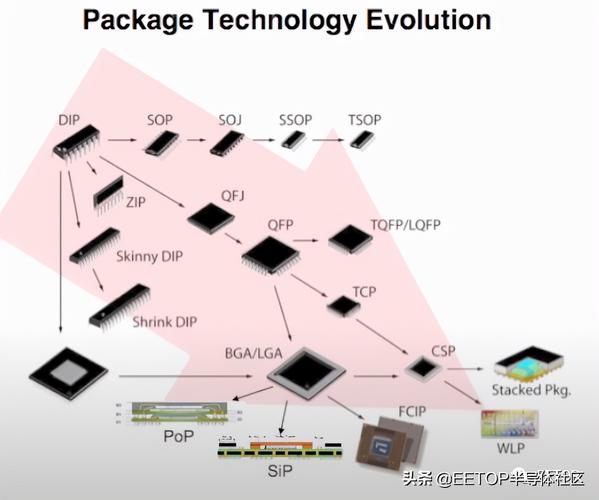
第二阶段
20世纪80年代是表面贴装时期,以薄型小尺寸封装技能(TSOP)为代表,到目前为止依然保留着内存封装的主流地位。改进的TSOP技能依然被三星、当代、Kingston等内存制造商所采取。
第三阶段
20世纪90年代涌现了超过式发展,进入了面积阵列封装时期,该阶段涌现了球栅阵列封装(BGA)为代表的前辈封装技能,这种技能在缩减体积的同时提高了系统性能。其次还有芯片尺寸封装(CSP)、无引线四边扁平封装(PQFN)、多芯片组件(MCM)。BGA技能的成功开拓,让一贯掉队于芯片发展的封装终于追上了芯片发展的步伐,CSP技能办理了长期存在的芯片小,封装大的抵牾,引发了集成电路封装领域的技能革命。
第四阶段
进入21世纪,封装技能迎来了三维封装、系统级封装的时期。它在封装不雅观念上发生了革命性的变革,从原来的封装元件观点演化成封装系统,紧张有系统级芯片封装(SoC)、微机电系统封装(MEMS)。
从材料介质方面,半导体封装包括金属、塑料、陶瓷、玻璃等。在军工和航天方面,由于芯片事情环境恶劣,以是大部分采取的是金属封装。陶瓷封装在电、热、机器等特性方面极其稳定,并且有较好的气密性保护和优秀的可靠度,但与塑料封装比较,它的工艺温度和本钱都较高。
各阶段具有代表性及常见的封装类型
双列直插式封装(DIP)
DIP是指采取双列直插形式封装的集成电路芯片,绝大多数中小规模集成电路均采取这种封装形式,其引脚数一样平常不超过100个。采取DIP封装的CPU芯片有两排引脚,须要插入到具有DIP构造的芯片插座上。当然,也可以直接插在有相同焊孔数和几何排列的电路板上进行焊接。Intel系列CPU中8088就采取这种封装形式,缓存和早期的内存芯片也是这种封装形式。
DIP封装具有以下的特点:
适宜在印刷电路板上穿孔安装,操作方便;
芯片面积与封装面积之间的比值较大,故封装体积也较大;
薄型小尺寸封装(TSOP)
TSOP内存是在芯片的周围做出引脚,采取SMT技能(表面安装技能)直接附着在PCB板的表面,在刚涌现时就得到业界广泛的认可,因此得到了极为广泛的运用。
TSOP封装具有以下的特点:
寄生参数(电流大幅度变革时,引起输出电压扰动) 减小;
适宜高频运用,操作比较方便,可靠性也比较高;
技能大略、成品率高、造价低廉等优点 ;
方形扁平无引脚封装(QFN)
方形扁平无引脚封装(QFN),表面贴装型封装之一,QFN与TSOP完备不同,TSOP封装仍有引脚,而QFN封装则完备没有任何引脚,而是在四侧配置有电极触点。
QFN封装具有以下特点:
QFN封装具有精良的导热性;
能供应精良的电性能;
体积小、重量轻;
球栅阵列封装(BGA)
球栅阵列封装简称BGA,采取BGA技能封装的内存,可以使内存在体积不变的情形下内存容量提高两到三倍,BGA封装的I/O端子以圆形或柱状焊点按阵列形式分布在封装下面。
BGA封装具有以下特点:
有较好的电热性能;
厚度和重量都较以前的封装技能有所减少;
寄生参数减小,旗子暗记传输延迟小,利用频率大大提高;
组装可用共面焊接,可靠性高;
芯片级封装(CSP)
芯片级封装简称CSP,是新一代的内存芯片封装技能。CSP封装可以让芯片面积与封装面积之比超过1:1.14,已经相称靠近1:1的空想情形,绝对尺寸也仅有32平方毫米,约为普通的BGA的1/3,仅仅相称于TSOP内存芯片面积的1/6。与BGA封装比较,同等空间下CSP封装可以将存储容量提高三倍。
CSP封装具有以下特点:
CSP封装是面积最小,厚度最小的封装技能;
CSP输入\输出端数比较其他封装技能可以做得更多;
电性能、热性能好等特点;
晶圆级芯片封装(WLCSP)
晶圆级芯片封装(WLCSP),WLCSP与传统的封装办法有所不同,传统的封装办法是先先切割再封测,而WLCSP是先在整片晶圆上进行封装测试,然后再一个个切割下来,因此封装后的体积和IC裸晶的尺寸大致相等。这种封装办法不仅仅缩小了封装的体积,而且符合对集体空间的高密度需求,同时在性能方面也得到了提升。
WLCSP封装具有以下的特点:
有效缩减了封装体积;
数据传输路径短、稳定性高;
具有精良的散热性;
微机电系统封装(MEMS)
微机电系统简称MEMS,是集微传感器、微实行器、微机器构造、微电源、微能源、旗子暗记处理和掌握电路、高性能电子集成器件、接口、通信即是一体的微型器件或系统。MEMS是一项革命性的新技能,广泛运用于高新技能家当,其内部构造一样平常在微米乃至纳米量级,是一个独立的智能系统。
MEMS封装具有以下特点:
微型化、智能化、多功能、高集成度;
适于大批量生产;
综上,目前环球半导体封装正处在第三阶段的成熟期和快速发展期,以TSOP、BGA等紧张封装形式为主流,并且进入大规模运用期间,同时向第四阶段发展。从发展进程可以看出,半导体封装技能的发展趋势可归纳为有引脚到无引脚,芯片级封装到晶圆级封装,二维封装到三维封装,从封装原件到封装系统的演化。
关注:石墨烯研究院
——本文部分内容来自百度百科
——石墨烯研究院编辑整理
(文中素材来自于网络公开信息,侵删,感激)
-THE END-












