▌IMP:Implant,中文:离子注入,又称之为离子植入,机理是:先使得待掺杂原子(分子)电离;然后离子在电场中被加速;高速离子射入到半导体中;最退却撤退火激活杂质。
由于炉管扩散工艺横向效应大,不能精确掌握掺杂浓度和分布, 随着器件尺寸的缩小,杂质分布哀求越来越浅,掺杂得精确度哀求越来越高。以是,在八零年代后,高真空离子注入工艺逐步取代扩散工艺(尤其是高阶制程)。

扩散和离子注入的差异:
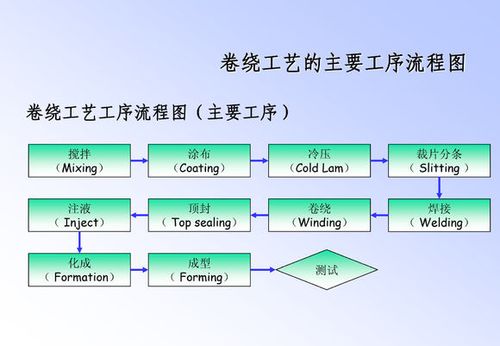
离子注入(IMP)工艺,便是将须要作为掺杂剂的BF3、 AsH3 和 PH3 等元素原子电离,转变为离子,同时将其加速到一定能量后,注入到Wafer晶圆表面,以改变Wafer晶圆表面的物理和化学性子。
▌离子注入的工艺紧张分为两类:中束流,高束流(分为高能量和高电流)
中束流:低掺杂浓度,紧张是用于较浅的结节处。
高束流:高掺杂浓度,紧张是用于较深的结节处。
离子注入工艺中的关键参数有三个:剂量,能量,高真空;
▌离子注入的优点如下:
1.原子经由质量剖析器进行电离,其纯度高,不受源纯度的影响。注入过程在高温和真空下进行,避免了污染的风险。
2.掺杂过程不受衬底上的杂质溶度限定。各种元素都可以进行掺杂,使得掺杂变得更为灵巧多样。
3.衬底无需经由长韶光高温加热,可用光刻胶掩蔽,使得自对准掩蔽技能更加的灵巧多样,这是扩散无法实现的。其余,衬底温度低,故离子注入时不会改变内部原 杂质的分布构造。
4.横向效应小,有利于杂质的高度集成。
5.通过调节离子能量能独立掌握结深。
6.通过调节离子电流乘以注入韶光可以掌握掺杂剂量。采取多重注入,可得到各种掺杂分布。
7.透过SiO2注入可调节MOS器件阈值电压。
8.可实现有机化合物半导体掺杂。(化合物半导体高温处理时组分会发生变革,采取 离子注入可使之不分解)。
▌离子注入也有些缺陷:
1.高速注入的离子对晶格有损伤(须要肃清,但某些情形是无法完备肃清的)。
2.很浅和很深的注入分布无法实现。(沟道效应,要有一个角度注入)
3.高剂量注入时,与扩散比较离子注入的产能是有限定的(尤其是与同时运行200片硅片的扩散工艺比较)。
4.其机台设备很昂贵(一台最新设备约2百万美金)。
以下是国产离子注入设备
大家有什么见地或建议,欢迎留言或私信,
▌点击上方“芯小虎”关注我,分享更多的芯片知识和新闻
▌如果喜好,请"点赞"+"在看"✿,感激















