芯片封装工艺流程
芯片封装工艺流程紧张可以分为以下几步:

一、芯片切割
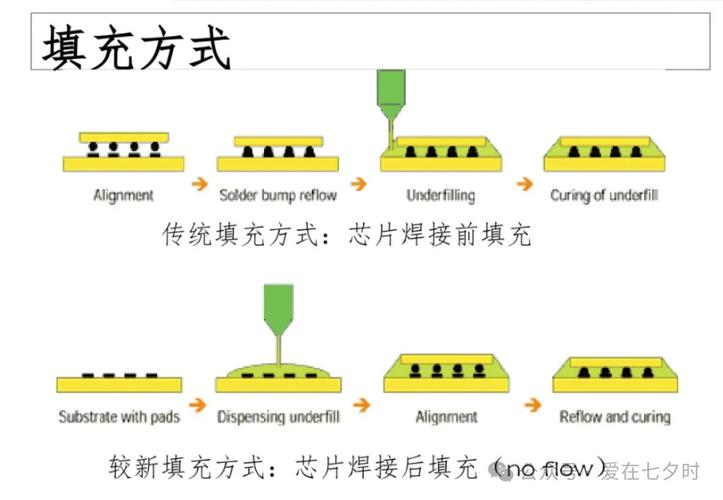
先在芯片背面贴上蓝膜并置于铁环之上,之后再送至芯片切割机上进行切割,目的是用切割机将晶圆上的芯片切割分离成单个晶粒。
二、晶粒黏贴
先将晶粒黏着在导线架上,也叫作晶粒座,预设有延伸IC晶粒电路的延伸脚,用银胶对晶粒进行黏着固定。
三、焊线
将晶粒上之接点为第一个焊点,内部引脚上接点为第二焊点,先把金线之端点烧成小球,再将小球压焊在第一焊点上。接着依设计好的路径拉金线,把金线压焊在第二点上完成一条金线之焊线动作。焊线的目的是将晶粒上的接点用金线或者铝线铜线连接到导线架上之内的引脚,从而将ic晶粒之电路讯号传输到外界。
四、封胶
将导线架预热,再将框架置于压铸机上的封装模具上,再以半溶化后的树脂挤入模中,树脂硬化后便可开模取出成品。封胶的目的是防止湿气等由外部侵入,有效地将内部产生的热量排出外部,供应能够手持的形体。
五、切脚成型
封胶之后,须要先将导线架上多余的残胶去除,经由电镀以增加外引脚的导电性及抗氧化性,而后再进行切脚成型。将导线架上已封装完成的晶粒,剪切分离并将不须要的连接用材料切除。
切脚成型之后,一个芯片的封装过程基本就完成了,后续还须要一些处理才能让芯片能够稳定高效的事情,包括去胶、去纬、去框等等,末了再测试考验,所有流程走完之后,确保芯片没有问题,这个时候芯片就能够正常的事情了。
















