BGA封装技能,即球栅阵列封装,是一种表面贴装技能,用于集成电路的封装。这种技能通过在芯片底部利用微球连接点(焊球)来与印刷电路板连接,从而实现了高密度封装,提高了电子产品的性能。BGA封装技能比较传统的封装办法,具有更小的体积、更好的散热性能和电性能上风。
PBGA基板(塑料球栅阵列封装基板)是一种常见的BGA封装形式,其特点是利用塑料基板作为封装材料,这种基板具有良好的可塑性和绝缘性,能够适应繁芜的电路布局需求,同时塑料材料也具有良好的散热性能,有助于提高芯片的稳定性。

CBGA基板(陶瓷球栅阵列封装基板)则是另一种BGA封装形式,它采取陶瓷作为基板材料。陶瓷基板具有优秀的绝缘性和耐高温性能,适宜在高负荷和高稳定性的运用环境中利用。陶瓷基板能够供应更好的电气隔离和保护,确保芯片在恶劣环境下的可靠运行。
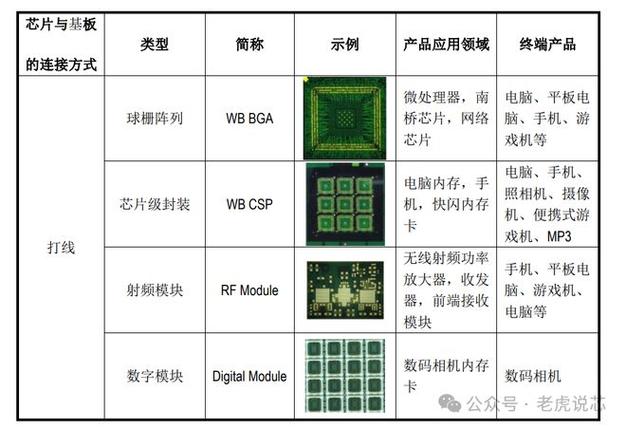
这两种封装形式各有特点,选择哪种形式取决于详细的运用需求,如体积、重量、散热需求、电气性能以及本钱等成分。PBGA因其本钱较低、体积小、散热性能好等优点,在大多数消费电子产品的芯片封装中得到广泛运用;而CBGA则因其优秀的绝缘性和耐高温性能,更适宜于对稳定性和安全性哀求更高的领域。













