#划片机(光力科技):前辈封装工艺的Chiplet,芯片的体积变小,芯片数量增多。对付半导体划片机来说,首先须要切更多的刀数,划片机的需求量肯定上升的。然后由于芯片变得更小,以是切割精度哀求也变得更高
#晶圆测试(长川科技赛腾股份):在封装中,必须要担保这十多个小芯片比必须无缺无缺。如果有一个芯片是坏的,全体大芯片都要一起报废。以是在前辈封装里面对于测试的哀求提高

#凸块工艺。(芯源微、劲拓股份)。凸块工艺便是在晶圆上栽种锡球,替代传统的引线键合工艺。凸块的一个工艺流程是涂胶显影曝光,利好芯源微。如果是铜凸块就用电镀的设备,让铜柱子长出来;如果锡凸块便是在用晶圆植球设备把锡球植到晶圆上面,然后再用回流焊设备把锡球融化、再冷却。劲拓股份本来是PCB回流焊现在拓展晶圆级回流焊设备。
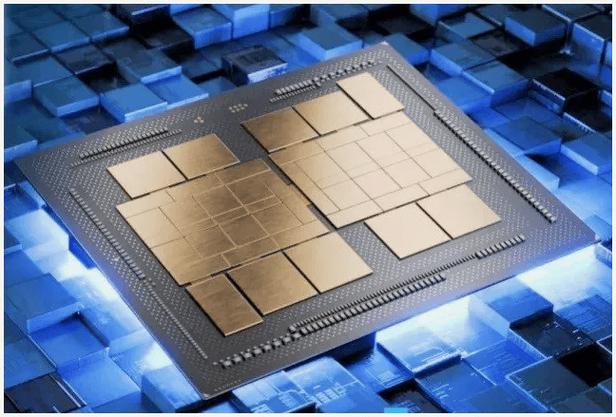
#固晶机。(新益昌)。由于芯片数量变多,并且变得更小,工艺对固晶需求量增加,同时精度需求提高,也带来了代价量的提高。
#减薄。(安集科技)减薄环节。传统的半导体封装的流程中,第一道背面减薄,用的是化学机器抛光设备,在前辈封装中,比如3D封装,须要把芯片叠好几层,为了让体积更加精细,须要把晶圆磨得更薄。因此减薄设备的需求量会增加。减薄设备标的?研磨抛光液需求也增加,安集科技。
#硅通孔工艺(北方华创中微拓荆)硅通孔的工艺首先是用蚀刻设备在晶圆上面去做凹槽,做完凹槽之后用薄膜沉积设备在上面做上绝缘层阻挡层。然后还有种子层,再今后面便是用电镀设备把铜的柱子给电镀出来。再往下面便是须要用背面减薄设备,是把凹槽下面那部分不导通的部分剪薄掉,这样就会形成一个贯穿孔。硅通孔工艺流程涉及到的设备大部分是前道设备,包括刻蚀设备、薄膜沉积设备、化学机器抛光设备。但是对这几个千亿公司绝对收入提升都不明显。
#光刻,曝光设备(芯碁微装,张江高科)。上海微电子是非直写光刻,芯碁微装是直写光刻。
#塑封设备。(文一科技)在前辈封装工艺中,构造更加繁芜,塑封难度增加。如果要保持原来的效率,塑封机的需求必须增加。
#其他材料标的:飞凯材料(键合股料的)兴森科技(载板)强力新材PSPI和bumping电镀液)。













