芝能智芯出品
随着摩尔定律的放缓和半导体行业面临的寻衅不断增加,芯片技能已经成为推动集成电路(IC)进步的关键方法之一。

尤其是具有明确功能的小芯片,可以与其他芯片合并到单个封装或系统中。芯片之间的密集互连可确保快速、高带宽的电气连接。
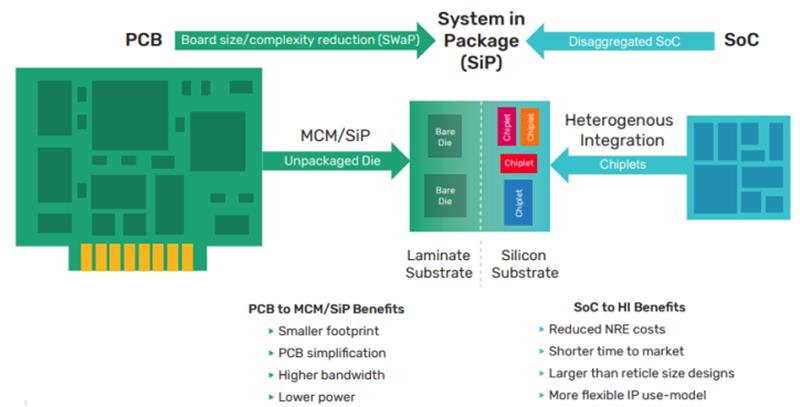
本文磋商了芯片技能的最新发展,尤其是在中介层和3D集成方法方面的创新,以将间距缩小到1µm以下。
备注:本文参考IMEC的文章《Chiplets: Piecing Together the Next Generation of Chips (Part I) Bridging the gap: innovations in chiplet interconnect technolgy》
Part 1
小芯片的兴起:
技能背景和上风
Chiplet芯片技能被《麻省理工科技评论》评为2024年十大打破性技能之一,在半导体领域取得了重大进展。这是小型模块化芯片,具有特定功能,例如可以稠浊搭配成完全部系的CPU或GPU。
这种类似乐高积木的方法使制造商能够灵巧地以较低本钱组建新芯片设计系统,并提高效率和性能。芯片实现优化的一种方法是计策性地定制技能。例如,IO和总线芯片利用可靠的传统节点,而打算芯片则采取尖端技能以实现峰值性能。内存芯片采取新兴内存技能,确保能够适应各种半导体需求。
● 分割大型单片系统芯片:办理摩尔定律放缓的问题
基于芯片的设计办理了过去几十年来推动半导体行业发展的摩尔定律的放缓问题。芯片制造商探索了使晶体管更小、将更多元件塞入芯片的方法,从而产生了规模可不雅观的单片系统级芯片(SoC)设计。
手机是单片设计成功的证明,将数学函数、显示、无线通信、音频等全部集成到一个100mm²的芯片中。然而,进一步的扩展本钱极高,而性能上风却微乎其微。因此,将大型、繁芜的SoC分成更小的芯片,并将它们连接在一起,为特定运用构建一个别系。
● 汽车行业的芯片集运用:灵巧性和效率
汽车行业是采取芯片集的空想选择,它供应了一种灵巧的电子架构,以基本功能芯片集为根本,并辅以特定组件,包括用于自动驾驶、传感器领悟和其他电子功能的芯片集。与升级单片SoC的漫上进程比较,模块化方法缩短了上市韶光,可以在车辆生产线的全体生命周期内改换或更新芯片集。
此外,汽车发卖量比手机等的销量要小。因此,为每种车型重新设计单片SoC将导致高昂的工程本钱。芯片集的灵巧性还可以帮助汽车制造商利用已在其他汽车设计中得到验证的芯片来知足可靠性和安全性哀求。
Part 2
连接砖块:
2.5D中介层技能
芯片能否成功跟上摩尔定律,很大程度上取决于芯片在一个封装内能被放置得有多近,以确保它们之间快速、高带宽的电连接。在2.5D集成中,芯片通过硅、有机聚合物、玻璃或层压板等公共基板连接。
硅中介层是一种成熟的高性能运用技能,具有最风雅的间距和良好的热电性能,但它们的本钱和繁芜性也更高。因此,有机基板作为替代方案得到了研究和优化。Imec供应的硅“桥”和超风雅再分布层(RDL)互连技能是两种替代方案。
● 3D片上系统:稠浊键合实现亚微米间距
某些运用(如高性能打算)可能须要高性能、更小的形状尺寸或更高等别的系统集成,更方向于采取完全的3D方法。晶圆到晶圆稠浊键合是集成3D-SoC到微米互连密度级别的关键技能。Imec的专有方法利用SiCN作为键合电介质,将互连间距缩小到700nm,未来可能达到400nm和200nm。
● 微凸块与稠浊键合:不同互连技能的比较
对付2.5D技能,利用小焊料凸块将芯片放置在中介层顶部,从而建立电气和机器连接。工业上的微凸块间距常日达到50µm到30µm之间。Imec正在研究如何将间距减小到10µm乃至5µm。
与2.5D中利用的微凸块比较,3D堆叠中的稠浊键合产生的间距要小得多。那么,是否可以在任何地方利用稠浊键合呢?
事实上,在芯片到晶圆的方法(基于硅)中,芯片可以键合到硅中介层,间距达到几微米。不是200nm,由于目前最好的芯片到晶圆放置精度靠近250nm,而前沿的晶圆到晶圆键合可以降落到100nm的叠加精度。键合设备和干系工艺的改进估量将进一步将这些数字降落50%。不过,稠浊键合涉及额外的加工步骤,例如表面活化和对准,这可能会影响制造本钱。
晶圆对晶圆键合、芯片对晶圆键合和微凸块将在本钱、间距、兼容性和互操作性之间共存。在2.5D中,芯片常日来自不同的供应商,并且已经经由了一系列测试和操作。微凸块将成为首选,由于它们供应了一种不须要表面处理的标准化方法。此外,对付有机RDL,微凸块仍旧是首选,由于有机聚合物在加热时会膨胀得更多,并且无法充分平坦化。
● 互连技能的未来方向:寻衅与机遇
随着规模化技能变得越来越繁芜,设计和加工本钱也越来越高,对付规模较小的运用来说,在最前辈的技能节点中开拓专用SoC变得越来越具有寻衅性。将功能和技能节点分身分歧的芯片组更具本钱效益,并且比采取尖端工艺技能的巨型芯片具有空间和性能上风。
模块化方法可以办理多芯片封装的繁芜性和本钱问题,但这种模式转变带来了特定的技能寻衅。尺寸只是寻衅之一。芯片研究的很大一部分致力于缩小互连和/或探索将各个部件组合在一起的不同观点。将芯片堆叠在一起时,散热问题和电力运送变得至关主要。末了,须要进一步的标准化事情,以确保不同芯片之间的兼容性和通信。
小结
芯片技能代表了半导体行业的未来发展方向。通过模块化设计和前辈的互连技能,芯片不仅办理了摩尔定律放缓的问题,还为各种运用领域供应了更灵巧、更高效的办理方案。
从2.5D中介层到3D片上系统,从微凸块到稠浊键合,芯片技能的创新不断推动着半导体技能的进步。随着技能的进一步发展,芯片将在更多领域中得到运用,推动电子设备性能的不断提升。
参考文献
《麻省理工科技评论》,2024年十大打破性技能Imec,芯片技能研究报告3DInCites,芯片集成技能文章












