文章目录
[+]
倒装芯片封装中倒装焊技能与下添补技能是影响产品质量的核心关键技能,航天七七一所前辈封装生产线从产品对位焊接、助焊剂洗濯、底部添补与固化三方面重点打破,通过细化工艺步骤,优化干系工艺参数、原材料及设备状态等,先后占领了产品焊接偏移、焊盘爬锡、虚焊以及焊点空洞、助焊剂残留、底部添补胶水气泡等技能难题,实现了芯片尺寸21mm×21mm,凸点尺寸100μm,凸点数量4300个的产品多轮加工,产品焊接精度<±5μm,底部添补胶水空洞率<2%,各项性能指标均知足或优于行业标准。这标志着航天七七一所已具备大尺寸倒装芯片产品的加工能力,并向多元化的三维集成技能方向不断前行。
图1 焊点描述

图2 底部添补超声波扫描效果
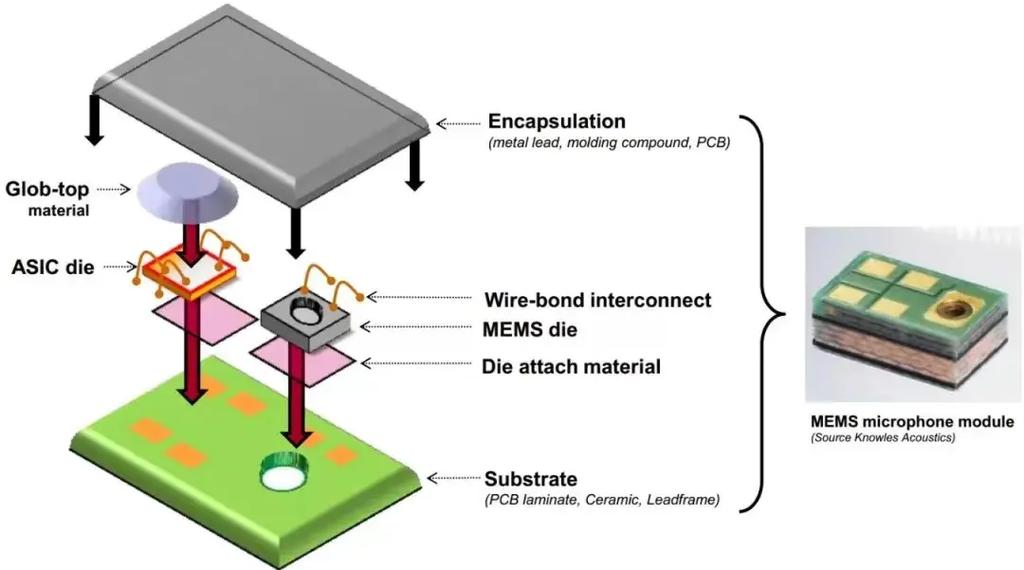
(图片来自网络侵删)
图3 完成焊接及底部添补后的倒装产品















