绝缘栅双极型晶体管(IGBT),结合MOS的高输入阻抗和双极型期间的电流密度的特性,暂时成为当下最高水平的功率器件。而传统的Si IGBT最高电压听说只能达到8.4KV,靠近Si器件的极限,但在高压和大电流的运用中依旧能够采取器件串并联,或者多电平的拓扑来填补电压上限。但是,频率和事情温度却限定了高压大功率领域中Si IGBT的发展,同时减少器件数量,简化系统构造也是发展趋势,须要器件新的打破。而第三代宽禁带半导体SiC的涌现,其在高压、高温、高功率的领域表现出更强的竞争力。
基于Si IGBT的优点,SiC IGBT同样也结合了SiC MOSFTE和SiC晶体管的优点,即SiC界的最高水平(当然,未来皆有可能,不局限于此)。但是,对付SiC IGBT,SiC/SiO2界面特性,电磁滋扰和短路耐受能力等却限定了它的利用。任何新事物涌如今大众视野之前,很多都是经历过一些发展的,实在早在1996年就有了第一个6H-SiC IGBT。

SiC IGBT的发展至少也有30年了,大众视野中很少会提及到SiC IGBT产品,并不是没有,只是太多事情是我们目不可及的。就目前而言,SiC器件的制成还有着很多难点须冲要破和解决,下面我们就来看看SiC IGBT的现状和寻衅。
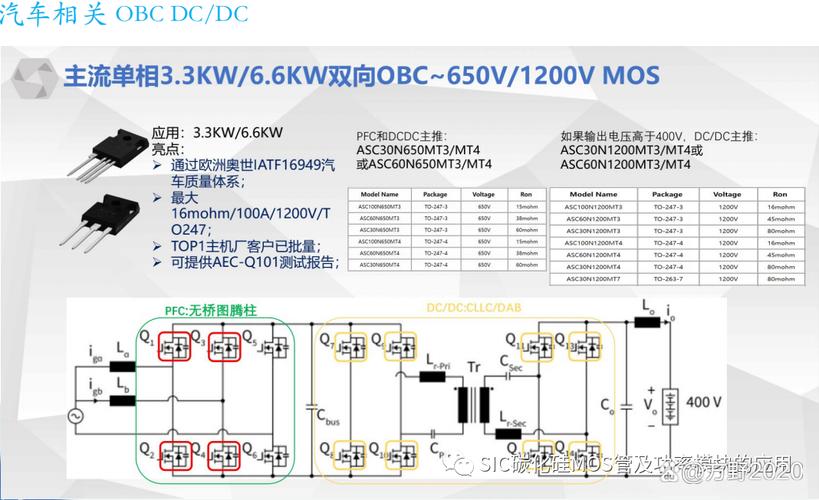
制备的寻衅
n沟道SiC IGBT的制备
从SiC IGBT的发展轴线图,我们可以看到SiC n-IGBT有着优的动静态性能,其须要高掺杂p型集电极作为空穴注入层。然后商用p型衬底的电阻率很高,质量较劣,这限定了SiC n-IGBT的性能发挥。而在独立技能提出之后,通过在n型衬底上成长出n-和p+来作为漂移层和集电极,使得n-IGBT得到进一步发展。
作为底层的p型外延层须要足够的厚度以及较高的掺杂浓度来担保机器强度和串联寄生电阻。但是在较厚的p型外延层中,掺杂浓度受薄欧姆打仗的形成、成长速率、表面粗糙度和成长毛病的限定。同时,由于SiC的硬度和化学惰性,使得n型衬底很难去除,这也须要进一步的完善工艺。
毛病,以及寿命增强
SiC晶片的质量直接决定了SiC IGBT器件的性能、可靠性、稳定性和产率,间接地影响制造本钱。SiC晶圆中的毛病紧张包括材料固有的毛病,外延成长引起的构造毛病,如微管、位错、夹杂和堆积等(在之前我们聊Si基制造工艺时有涉及)。通过优化成长工艺和成长后处理工艺,使得这些毛病被降到了合理的范围,这使得低压4H-SiC MOSFET器件得到商业化。而对付SiC IGBT来说,上述毛病作为复合中央,大大降落了载流子的寿命,高压SiC双极型器件须要很长的载流子寿命来降落导通压降,此外,载流子寿命也主导这导通压降和开关速率之间的折衷,以是须要进行寿命增强。
可以通过C+离子注入/退火、热氧化/退火或者是优化成长条件来降落影响载流子寿命的毛病密度,但是这相对付10kV以上的SiC IGBT来说,这些方法还是足以知足,除此之外,寿命分布的不屈均性,不同毛病密度之间的权衡,成长后产生的目标毛病和新毛病之间的权衡等等,都是阻碍SiC IGBT商业化的成分。
大尺寸、高质量材料和低毛病密度外延成长工艺都是实现SiC IGBT的关键。
SiC/SiO2界面性能
SiC 比较于Si IGBT的性能更优,但是还是利用SiO2来作为栅极的氧化层,带来了SiC/SiO2界面的新问题。SiC IGBT可以像Si基的一样较随意马虎形成SiO2层,但是在氧化的过程中,除了近界面陷阱外,还会引入额外的C簇,使得SiC/SiO2界面陷阱密度远大于Si/SiO2,导致SiC MOS的沟道迁移率大大降落。引入氮是降落退却撤退火中界面陷阱密度的有效方法,但是氮的引入造成了新的毛病,造成了可靠性的问题。所以为了得到高质量的SiC/SiO2界面,就须要完备去除剩余的C原子和近界面陷阱。
还有个紧张的问题便是氧化层的高电场。在4H-SiC IGBT中,SiO2中的电场是SiC中的2.5倍,与Si IGBT比较,SiC IGBT中较高的临界电场使得SiO2的电场更高。有些研究利用高介电常数的介电体代替SiO2来降落栅绝缘层和SiC之间的电场比,但是新介质和SiC界面带偏置较低,其界面毛病密度大,泄电流较大,虽然一定程度长进步了沟道迁移率,但是和现有大规模制造的兼容性以及在高压工况下的长期稳定性难以处理。
终端技能
为了担保SiC IGBT的高压,可靠和坚固的终端是必须的,终端能够担保器件能够支持大于90%的整体击穿电压。结端扩展(JTE)和场限环(FLRs)是目前SiC IGBT的两种紧张终端技能。为了缓解边缘电场效应,SiC IGBT的终止长度要比Si基的长很多,终端面积占了全体芯片面积的50%以上,导致芯片面积较大。
精确掌握注入剂量和优胜的面积利用是JTE技能实现均匀电场的必要条件,因此JTE紧张用于低压器件。而FLR技能紧张用于高压器件,但其在高压器件中须要花费很大的面积。针对这一问题,提出了线性或区域优化间隔的FLRs技能,缩短了30%的终止长度,增加了23%的击穿电压;以及JTE和FLR结合的JTE环技能,在相同的击穿电压减小了20~30%的终端面积。
封装技能
目前,SiC IGBT仍封装在线绑定的模块中,绑定线失落效和焊料的失落效是常见的寿命限定成分。此外,超高压带来的电压击穿和局部放电给绝缘材料带来了更大的寻衅。导体、介电体和封装体间的交点是暴露于高电场下的薄弱点,因此须要选用高击穿电场的材料、光滑的电极及电极间隙,这些都须要大量的研究,同时绝缘层介电常数高导致的额外位移电流,处理的繁芜性和模块尺寸增大等问题也是寻衅。
其余,提高模块的耐温能力,降落模块的热阻等也是尤为主要的,这些都还须要不断的创新。目前的纳米银烧结,双面冷却等技能可能能够办理部分SiC IGBT模块的需求,但还不敷够。
新的IGBT构造
只管SiC IGBT在阻断电压、导热系数和开关速率等方面优于Si IGBT,但是传统的IGBT构造一定程度上限定了SiC材料性能的发挥。为了提高SiC IGBT的电气性能和可靠性,新型IGBT构造在正在不断的发展。
特性和驱动
SiC的宽禁带和极高的电压等级使得其IGBT性能与Si基IGBT有着差别,紧张便是动静态特性。
静态特性
正向特性是静态特性的主要组成部分,也便是导通特性,可以用正引导通电阻Ron来描述。SiC IGBT的Ron一样平常低于Si IGBT和SiC MOSFET,紧张是由于其漂移区厚度小,电导调制更短导致的。其余p沟道的SiC IGBT的正向特性要比n沟道来的差,以是n沟道SiC IGBT是较优的。
动态特性
想较为直不雅观的理解IGBT的动态特性,双脉冲测试可以说是较为有效的手段。与Si IGBT类似,SiC IGBT由于其材料的特性,导致动态参数有所不同。
门极驱动
SiC IGBT的驱动和Si基的在整体上是差不多的,须要考虑到高绝缘性能、低耦合电容、低本钱、尺寸、高效率和高可靠性等成分。目前仍延用Si IGBT或者MOSFET的拓扑构造和掌握策略,只是细节可能会有所不同。
目前,第三代宽禁带半导体的热潮已经开始蔓延,不管是SiC还是GaN,都在不断的发展,各种类型的器件也都在不断推出。但SiC材料的功率器件,还是MOSFET较为常见,大概只有固定的高压,大电流,大功率的运用才会涉及到SiC IGBT。当然,相信未来SiC将会涌如今越来越多的传统Si基器件。
文稿来源:功率半导体的那些事儿










