CMP(Chemical Mechanical Polishing,化学机器抛光)是半导系统编制造过程中 实现晶圆全局均匀平坦化的关键工艺。晶圆制造过程紧张包括7个相互独立的工艺流程:光刻、刻蚀、薄膜成长、扩散、离子注入、化学机器抛光、金属化。作为晶圆制造的关键制程工艺之一,化学机器抛光指的是,通过化学堕落与机器研磨的协同合营浸染,实现晶圆表面多余材料的高效去除与全局纳米级平坦化。
由于目前集成电路元件普遍采取多层立体布线,集成电路制造的前道工艺环节须要 进行多层循环。在此过程中,须要通过CMP工艺实现晶圆表面的平坦化。CMP便是能有效令集成电路的“楼层”达到纳米级全局平整的一种关 键工艺技能。集成电路制造是CMP设备运用的最紧张的场景,重复利用在薄膜沉 积后、光刻环节之前;除了集成电路制造,CMP设备还可以用于硅片制造环节与 前辈封装领域。

当前CMP已经广泛运用于集成电路制造中对各种材料的高精度抛光。按照被抛光 的材料类型,详细可以划分为三大类:(1)衬底:紧张是硅材料。(2)金属: 包括Al/Cu金属互联层,Ta/Ti/TiN/TiNxCy等扩散阻挡层、粘附层。(3)介质:包 括SiO2/BPSG/PSG等ILD(层间介质),SI3N4/SiOxNy等钝化层、阻挡层。
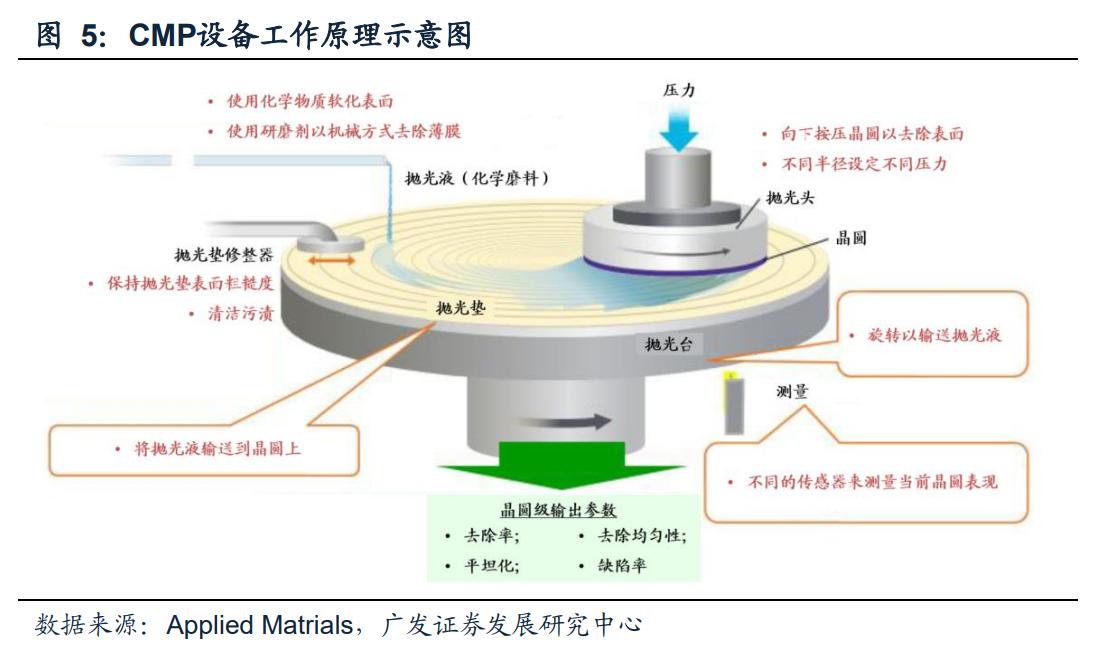
个中,在90~65nm节点,浅槽隔离(STI)、绝缘膜、铜互连层是CMP的紧张研磨对 象;进入28nm后,逻辑器件的晶体管中引入高k金属栅构造(HKMG),因而同时 引入了两个关键的平坦化运用,包括虚拟栅开口CMP工艺和替代金属栅CMP工艺。
STI-CMP:浅槽隔离(STI)氧化硅抛光。在硅晶片上以反应性蚀刻形成沟槽后, 以化学气相沉积的办法沉积二氧化硅膜再将未被埋入凹沟内的二氧化硅膜以CMP 去除。这样就可以用二氧化硅膜作为元器件间的隔离,再用抛光速率相对缓慢的膜 (例如氮化硅膜)来作为CMP的研磨停滞层(Stoplayer)。
ILD-CMP/IMD-CMP:ILD-CMP指的是层间介质(ILD)抛光,IMD-CMP指的是 金属内介电层(IMD)抛光,紧张抛光工具是二氧化硅介质。作为芯片组件隔离介 质,集成电路制造工艺中最常被利用的介电层是相容性最佳的二氧化硅介质。二氧化硅膜的CMP大多运用在层间绝缘膜及组件间的隔离(Isolation)平坦化工艺中。
ILD-CMP(层间绝缘膜平坦化)将导线或组件上的层间绝缘膜平坦化,以便完成 接下来的多层互连线工艺,是完成多层互贯串衔接构的根本,为大规模集成电路工艺中 不可短缺的步骤。IMD-CMP(元器件间隔离膜平坦化)目的在于形成平坦的氧化 硅膜(组件与组件间的绝缘隔离层)。在层间绝缘膜的平坦化方面CMP工具还有等离 子体增强化学气相沉积(PECvD)膜、硼磷硅玻璃膜(BPSG)及热氧化膜(Thermalox 记e)等。
Cu-CMP:随着集成电路层数的不断增加,在铜布线工艺中新的层间导线连接办法 “打仗窗”得到广泛运用,这种工艺方法也称为“大马士革工艺”(Damascene)。 大马士革工艺,首先在两层电路间的绝缘膜上进行刻蚀,使之形成凹槽(打仗窗), 再进行连接金属导线膜的沉积,末了以CMP办法去除金属膜。在双大马士革中, Cu-CMP用来抛光通孔和双大马士革构造中细铜线,双大马士革工艺过程中用介质 作为停滞层。
(二)抛光技能与洗濯、工艺掌握技能并重
CMP的作业事理:抛秃顶将晶圆待抛光面压抵在粗糙的抛光垫上,借助抛光液腐 蚀、微粒摩擦、抛光垫摩擦等耦合实现全局平坦化。抛光盘带动抛光垫旋转,通过 前辈的终点检测系统对不同材质和厚度的磨蹭实现3~10nm分辨率的实时厚度丈量防止过抛,更为关键的技能在于可全局分区施压的抛秃顶,其在限定的空间内对 晶圆全局的多个环状区域实现超精密可控单向加压,从而可以相应抛光盘丈量的膜 厚数据调节压力掌握晶圆抛光描述,使晶圆抛光后表面达到超高平整度,且表面粗糙度小于0.5nm,相称于头发丝的十万分之一; 此外制程线宽不断缩减和抛光液配方愈加繁芜均导致抛光后更难以洗濯,且对 CMP洗濯后的颗粒物刷领哀求呈指数级降落,因此须要CMP设备中洗濯单元具备 强大的清洁能力来实现更彻底的清洁效果,同时还不会毁坏晶圆表面极限化微缩的 特色构造。
对CMP设备而言,其家当化关键指标包括工艺同等性、生产效率、可靠性等,CMP 设备的紧张检测参数包括研磨速率、研磨均匀性和毛病量。
(1)研磨速率:单位韶光内晶圆表面材料被研磨的总量。
(2)研磨均匀性:分为片内均匀性和片间均匀性。片内均匀性指某个晶圆研磨速 率的标准方差和研磨速率的比值;片间均匀性用于表示不同圆片在同一条件下研磨 速率的同等性。
(3)毛病量。对付CMP而言,紧张的毛病包括表面颗粒、表面刮伤、研磨剂残留, 这些将直接影响产品的成品率。
为了实现这些性能,CMP设备须要运用到纳米级抛光、洗濯、膜厚在线检测、智 能化掌握等多项关键前辈技能。CMP产品的技能水平也紧张取决于设备在抛光、 洗濯、工艺智能掌握等核心模块/技能的表现。详细可以分为两大类:
(1)抛光技能。可以实现纳米尺度的“抛的光”、晶圆全局“抛得平”,这是CMP 工艺的根本。
(2)赞助、掌握技能。详细包括纳米级的洗濯、膜厚在线检测、智能化掌握等, 这些是实现CMP工艺的主要的赞助技能,浸染在于晶圆抛光动作“停得准”、以及抛光后纳米颗粒“洗得净”。常日CMP工艺后的器件材料损耗要小于全体器件厚度的10%,也便是说CMP不仅要使材料被有效去除, 还要能够精准的掌握去除速率和终极效果。随着器件特色尺寸的不断缩小,毛病对 于工艺掌握和终极良率的影响愈发明显,降落毛病是CMP工艺的核心技能哀求, 因而当前对CMP设备而言,除了抛光技能,包括洗濯技能、工艺掌握技能等赞助 类技能的主要性愈发突出。
抛光:在CMP发展过程中,CMP逐步由最初的单头、双头向着多头方向发展;抛光构造方面,目前处于轨道抛光方法、线性抛光、与旋转构造抛光并存状态,个中旋转构造霸占主流;在抛光驱动技能方面,随着客户哀求提高以及电机技能发展,直驱式已成为高端机型的紧张驱动办法。
终点检测:要检测抛光的终点,须要实时得到被抛光薄膜的厚度。CMP的终点判 断便是判断何时到达CMP的空想终点,从而停滞抛光。在构造微细化、高精度要 求下,晶圆膜厚哀求精度掌握在0.1nm,些许偏差都将对薄膜的力学性子、光学性 质以及器件的设计以及可靠性产生主要影响。准确的终点监测是产品成品率、加工效率的关键技能,直接影响到本钱与市场竞争力。
电极电流终点检测:其事理是当晶圆抛光达到终点时,抛光垫所打仗的薄膜材料不 同,导致晶圆与抛光垫之间的摩擦系数发生显著变革,从而使抛秃顶或抛光机台回 转扭力变革,其驱动电机的电流也随之变革,因此由安装在抛秃顶和抛光机台上的 传感器监测驱动电机电流变革可推知是否到达抛光终点。
CMP后洗濯:在CMP工艺中,抛光液中的磨料和被去除的材料作为外来颗粒(含 金属颗粒)是CMP工艺的污染源,CMP后洗濯的重点是去除抛光过程中带有的所 有污染物。当前CMP机台已经把CMP工艺和洗濯工艺集成在一起,而且哀求干进 干出,包含洗濯与干燥两大环节。随着晶圆表面清洁度哀求的不断提高,CMP清 洗工艺的焦点已逐步由洗濯液、兆声波等转移到晶圆干燥上。
第1代CMP后洗濯技能:该阶段半导体CMP设备市场初步形成,市场紧张设备包括 Strasbaugh公司的6DS-SP以及Westech的PEC372/372M。这期间的CMP后洗濯, 紧张是抛光后再将整盒的晶圆提出来放置到单独的洗濯机进行洗濯,采取多槽浸泡 化学湿法洗濯技能,紧张运用于较大线宽的集成电路,而且洗濯韶光较长,一样平常都 会大于1个小时,与CMP衔接性能也较差。
第2代CMP后洗濯技能:代表设备是运用材料的适用于8英寸的Mirra。Mirra采取在 线洗濯系统,洗濯仍旧是在单独的洗濯机台中完成,不过Mirra和洗濯机台之间有 机器接口和传输装置,CMP作为主机直接调度洗濯机台菜单,来完成CMP后洗濯。 Mirra后洗濯系统采取两次双面洗擦+旋转甩干,同事可以根据须要选择超声或者兆 声洗濯。但由于CMP设备和后洗濯设备都是单独的机台,占地妙计较大,在21世 纪后逐渐被集成洗濯技能所取代。
第3代CMP后洗濯技能:分立式CMP的后洗濯机台被集成进CMP设备机台内。代表设备是运用材料的Mirra-mesa,个中垂直洗濯是显著特色,也是运用材料的核心技能之一。一方面可以得到更加清洁的晶圆,另一方面大幅度减少CMP设备的构造空间。同期日本荏原公司推出的OPTO 222机台采取水平的后洗濯技能,明显处于劣势地位。Mirra-mesa后洗濯采取1次单片垂直兆声洗濯+2次垂直双面洗濯+ 垂直旋转甩干。
第4代CMP后洗濯技能:2006年后运用材料推出300mm的Reflexion LK机台,面向 铜抛光,在市场上得到良好反应。除了同样采取垂直兆声洗濯+垂直双面洗擦外, 将干燥技能由之前的旋转甩干改换为IPA-WAPOR干燥法,使得CMP洗濯后的硅片毛病比传统方法得到了显著改进,同时干燥效率得到大幅 提升。
第5年CMP后洗濯技能:紧张是在原来机台上,对核心技能模块进行工艺改进,以 适用更小技能节点的需求;其余通过更多的抛光、洗濯模块来实现更高产能。运用 材料的Reflexion LK机台最初是针对130nm-65nm的量产设备,已经将技能延伸至 20nm以下;而最新一代产品Reflexion LK Prime机台,可以用于FinFET和三维 NAND,除了与Reflexion LK一样采取最前辈的抛光、洗濯和工艺掌握技能,其余配备了4个研磨垫、6个研磨头、8个清洁室以及两个干燥室,生产效率是Reflexion LK的两倍。
根据华海清科招股书,环球高端CMP厂商紧张有美国运用材料、日本荏原和华海清科,几家公司CMP产品作业的核心机理相同,紧张是在抛光盘驱动办法、终点检测手段、后洗濯干燥技能等技能方案有所差异。总体上,华海清科的CMP产品在已量产的制程(14nm以上)以及工艺运用中与外洋龙头公司的紧张产品不存在 技能差距,在客户端产线上已可以实现对行业龙头公司产品的替代。但在14nm以 下,对CMP设备的特定模块/技能水平的哀求更加严苛,紧张包括洗濯与干燥技能、 工艺掌握等赞助技能方面,华海清科产品与外洋龙头公司仍旧存在一定差距。
CMP后处理的颗粒残留:华海清科采取的竖直旋转技能体系(VRM)的工艺潜能尚在提升,在14nm以上制程工艺中与外洋龙头均能达到特定颗粒物不超过50个的目标,但在14nm以下制程工艺中外洋龙头公司产品内最前辈的CMP后处理单元的 颗粒残留可能已达更低。
金属离子含量:28-14nm制程中,华海清科产品与外洋龙头公司产品均能达到金属离子含量不超过没平方厘米含有的(特定)原子数为510^10个的目标,但在更前辈制程工艺中外洋龙头公司产品的该技能表现可能更高。
(三)技能继续性良好,前辈制程运用需求显著提升
CMP设备发展背景:进入ULSI时期之后,集成电路制造向垂直空间发展,匆匆使多层金属互联技能的涌现。而多层金属互联技能的涌现导致IC制造过程中不可避免的在层与层之间产生台阶,层数越多表面起伏越明显。明显的表面起伏紧张有两方面的影响:(1)金属布线中随意马虎导致断路、短路。(2)光刻时对线宽失落去掌握。 各种半导体材料的高度平坦化成为工艺发展的瓶颈,进而各种平坦化技能运用而生, 包括回蚀法(Etch back)、薄膜沉积法、旋涂玻璃法(SOG)、化学机器抛光(CMP) 等,个中除了CMP以外,其他方法都用来实现局部平坦化。
CMP发展可以分为3个阶段:
(1)研发期:1965~1988年。紧张用于氧化物及金属邬等;
(2)成熟期:1988~2000年,CMP工艺逐渐发展为IC制造过程中必不可少的关键 工艺技能。两个关键节点,一个是从0.35~0.25μm开始,CMP技能成为唯一可实 现全局平坦化的IC关键技能;另一个从0.18~0.13μm开始,铜正式取代铝成为主流 导线材料,CMP成为铜互联技能必不可少的工艺制程。
(3)领域延伸期:2000年以来,随着IC制造技能节点的不断延伸,CMP工艺逐渐 朝着低K介质、低压力、铜互连技、钌阻挡层的方面发展。
CMP设备在较永劫光内不存在技能迭代周期。当前CMP仍是集成电路制造大生产 上产出效率最高、技能最成熟、运用最广泛的纳米级全局平坦化表面制造设备,其 具有突出的材料均匀去除与纳米毛病高效掌握上风。同时,CMP设备在较永劫光 内不存在技能迭代周期,运用于28nm和14nm的CMP设备没有显著的差异,仅是 特定模块技能的优化。CMP工艺由14nm持续向7nm、5nm、3nm前辈制程推进过 程中,CMP技能将不断趋于抛秃顶分区风雅化、工艺掌握智能化、洗濯单元多能 量组合化方向发展,抛光驱动技能、压力调控技能、智能掌握系统、终点识别检测 系统以及智能洗濯模块等关键模块技能将是CMP技能未来发展的主冲要破方向。
从环球化学机器抛光专利历年申请量来看,2000-2005年是CMP专利申请高峰期, 对应的是Cu互联技能发展进一步促进CMP广泛运用的期间,2009-2013年属于专利申请低谷期,紧张是行业需求在这期间处于下滑阶段。2013年以来CMP专利申请量缓慢增长,而CMP后洗濯专利申请量却处于下滑状态。环球CMP专利申请量总体保持平稳,反响了当前环球CMP技能未存在重大技能改造。
CMP设备占晶圆制造设备的4%旁边,前辈制程CMP步骤显著增加。 2018年环球CMP设备的市场规模18.42亿美元,约占晶圆制造设备4%的市场份额, 个中中国大陆CMP设备市场规模4.59亿美元。设备单价方面,用于200mm圆片的CMP设备价格约300万美元,300mm晶圆的CMP设备价格约 400万美元。
CMP设备分类看,CMP的紧张浸染是实现晶圆不同介质层的整体平坦化,目前行 业内通用按所运用的12英寸或8英寸晶圆尺寸分为12英寸和8 英寸CMP设备。作为集成电路生产中的环节之一,CMP设备紧张根据运用芯片领域,客户工艺特色和利用耗材的不同对模块性能进行差异化调度和定制化设计,不存在进一步细分产品种别。
随着芯片制造技能发展,CMP工艺在集成电路生产流程中的运用次数逐步增加,以逻辑芯片为例,65nm制程芯片须要经历约12道CMP 步骤,而7nm制程所须要的CMP处理增加至30多道。随着前辈制程对CMP运用步骤增加,CMP需求占比有望进一步提升。
(四)向上往耗材、向下朝做事领域延伸
CMP设备是利用耗材较多、核心部件有定期维保更新需求的制造设备之一。基于 CMP工艺特点,CMP设备正常运行过程中,除了须要利用抛光液、抛光垫等通用耗材外,设备自身的抛秃顶、保持环、气膜、洗濯刷、钻石碟等关键耗材也会快速损耗,必须进行定期维保更新。美国运用材料与日本荏原均有为客户供应CMP设备关键耗材发卖和维保业务。
2020年华海清科配套材料与技能做事收入3260万元,占当年业务收入的8.45%, 个中耗材、技能做事及其他收入分别为824、2437万元,毛利率分别为32.3%、 60.7%。目前华海清科关键耗材发卖和维保业务紧张针对已发卖的CMP设备,向客户供应设备关键易磨损零部件的维保、更新做事,以担保设备的稳定运行。目前公司向客户发卖的关键耗材紧张包括保持环、探测器、气膜、7分区抛光头等,维保做事紧张包括向客户供应7分区抛秃顶维保。
其余,CMP设备是晶圆再生的核心工艺设备之一,其余设备发卖与晶圆再生做事 面向相同领域客户,设备商向下贱做事领域延伸可以与原有业务形成较高协同。晶圆再生工艺流程紧张是对控挡片进行去膜、粗抛、精抛、洗濯、检测等工序处理, 使其表面平整化、无残留颗粒;个中精抛及部分洗濯是通过CMP设备来完成。晶 圆再生业务的技能难点紧张在于对再生晶圆表面平整度、毛病和晶圆表面的纳米级 颗粒残留、金属离子残留的掌握哀求极高,这些哀求紧张通过CMP设备来实现, 因此CMP工艺和技能是晶圆再生工艺流程的核心和难点,CMP设备也是晶圆再生 工艺产线中资金投入最大的设备。
目前再生晶圆的利用量估计占半导系统编制 造线输入晶圆总量的20%。长期看,晶圆厂出于对本钱节约的考虑,有望增加对再 生晶圆的需求;此外,前辈制程产品制造须要更多的再生晶圆。而随着外部能供应 更多高质量再生晶圆,晶圆厂对晶圆再生做事外包的需求有望进一步增强。根据不雅观 研网的数据,65nm制程的晶圆代工厂每10片正片须要加6片挡控片,28nm及以下 的制程每10片正片须要加15-20片挡控片。
2018年环球硅片发卖额112亿美元,而环球再生晶圆发卖额6亿元。总 体上,环球再生晶圆市场规模大致占环球硅片市场规模的5%~6%。
从2016年开始海内晶圆厂掀起了扩产浪潮,紧张以12寸晶圆产线为主。目前已经 有浩瀚产线完成一期培植、并逐步产能爬升。海内下贱晶圆产能迅速爬升,将有力 带动海内再生晶圆市场需求。根据SEMI,我国大陆已投产12寸晶圆产线超过20条, 在建的有8条,建成后全国产能将超过239万片/月,产线总投资额超过15000亿元。 如果目前已建以及在建12寸晶圆厂全部达产,按照再生晶圆数量占总数量30%、 再生晶圆产品良率90%、单片再生晶圆价格40美元/片,则海内再生晶圆市场空间 可以达到382百万美元。按照年底海内12寸晶圆厂产能打算,海内再生晶圆需求将 达到20万片~30万片。
海内目前对晶圆再生业务已经展开布局或者开展业务的公司包括至纯科技、华海清 科、协鑫集成等。公司已经打通整套晶圆再生工艺流程, 并于2020年起开始小规模生产,客户反响良好。公司操持投资3.59亿元用于再生 晶圆项目,项目建成后具备月加工10万片12英寸再生晶圆的生产能力。
二、环球双寡头格局,国产装备崛起(一)美国 AMAT 与日本 EBARA 垄断环球 90%以上市场
在CMP市场形成的早期,市场迅速的形成了高度集中化的竞争格局。在1997年前 后铜正式取代铝成为主流导线材料,CMP成为铜互联技能必不可少的工艺制程, 以此进一步推动了CMP的大规模运用。当时,环球CMP设备厂商有20家旁边,其 中包括SpeedFam、Westech(IPEC)公司都是当时霸占领先地位的紧张厂商, 但随着美国运用材料于1997年推出第一款产品Mirra CMP正式进入CMP设备市场, 到1999年其以迅猛的发展态势迅速将市场份额扩展至32%,并从此之后一贯霸占 市场的主导地位。而IPEC和SpeedFam都在运用材料和荏原公司的竞争中萎缩了。
2017年环球CMP设备市场规模17.5亿美元,个中运用材料12.4 亿美元,日本荏原4.7亿美元,由此打算运用材料的份额为71.3%、日本荏原的份 额为26.7%,两者合计霸占环球CMP市场的90%以上市场份额。
运用材料:运用材料(AMAT)是环球最大的半导体设备供应商之一,业务涵盖半 导体设备、太阳能、显示器、自动化软件、卷对卷真空镀膜等多个领域。在半导体 设备业务版块,公司制订了PPACt计策旨在通过并行而非串行的创新来推动芯片的 能效、性能、面积、本钱和上市韶光改造。公司产品覆盖沉积、刻蚀、掺杂、CMP 多工艺环节。 2020年运用材料在刻蚀、沉积、CMP、离子注入、 工艺掌握领域的环球市场份额分别达到了17%、43%、64%、55%和12%。2020 年公司总体收入172亿美元,半导体装备发卖收入合计113.67亿美元,同比增长 26%,个中CMP设备发卖收入11.33亿美元,同比增长18%。
CMP设备领域,运用材料自2003年开始主攻12 英寸设备,目前主打MIRRA®和 REFLEXION®两个系列。
(1)定位200mmCMP平台的MIRRA® ,为硅、浅沟槽 隔离 (STI)、氧化物、多晶硅、金属钨和铜镶嵌运用供应了150mm和200mmCMP 方案,多区研磨头具有较小的下压力,系统采取全套端点方法,供应同线度量和先 进的工艺掌握能力,确保出色的晶圆内和晶圆间工艺掌握和可重复性,可实现极佳的均匀度和效率。(2)定位300mmCMP平台的Reflexion® LK,为铜镶嵌、浅沟 槽隔离、氧化物、多晶硅和金属钨运用供应性能CMP方案,可扩展用于45nm以下 器件。升级后的Reflexion® LK Prime®整合了最新的抛光、洗濯和干燥技能,是业 界目前唯一的三转盘式顺序抛光平台。由4个抛光垫、6个抛秃顶掌握,工艺腔相 较LK的7个增加至14个,研磨洗濯产能更加,可在FinFET和3D NAND运用中达到 纳米级精度。
日本荏原:Ebara成立于1912年,目前旗下有3块业务,分别是:(1)流体机器及 系统,紧张包括泵、压缩机、涡轮机、鼓风机等,紧张用于石油、天然气、液化天 然气等;(2)环境工程,包括市政垃圾点火厂、工业垃圾点火厂、水处理厂等; (3)精密电子,包括干式真空泵、CMP(化学机器抛光)设备、电镀设备及排气 处理设备,紧张用于半导体、平板显示、LED和太阳能电池等领域。根据公司的介 绍文件,公司在液化天然气泵领域环球市占率第一,在CMP系统和干泵领域环球 市占率第二,CMP装置累计出货量2,500台以上。公司2020年业务收入约49.1亿美 元,流体机器及系统部门占约60%,精密东西部门占约27%,环境工程部门占约 13%。精密东西部门中CMP设备收入约5.14亿美元,同比增长25.8%,占环球CMP 市场份额的29.1%,仅次于运用材料。
在CMP领域,Ebara是干进/干出(dry-in/dry-out)专利的开拓者,独立研发的200 mm和300 mm CMP抛光设备均具有高可靠性和高生产率。F-REX系列CMP系统可 实现10-20nm节点的表面平整度掌握,用于IC制造的氧化物、ILD、STI、钨和铜 表面处理。它们具有出色的可靠性,性能超过250小时MTBF。F-REX200工具代表了适用于200 mm晶圆的最新CMP技能(也可用150 mm)。它采取Ebara原创 的干进干出(Dry-in/Dry-out)晶圆处理技能专利。清洁模块集成在CMP工具内,从 而将干晶片运送到后续工艺中。F-REX200系统配备2个压板,每个压板1个头和4 个清洁站,可选配4个盒式SMIF兼容装载端口和CIM主机通信。
(二)国产化取得主冲要破,国产替代有望加速
国产装备已经在海内CMP市场霸占主要份额。海内CMP市场,目前在高端市场部 分,绝大部分仍旧依赖于入口,在14nm以下最前辈制程工艺的大生产线上所运用 的CMP设备仅由美国运用材料和日本荏原两家国际巨子供应。运用材料与日本荏 原分别已实现5nm制程和部分材质5nm制程的工艺运用;但是在成熟制程领域,以 华海清科为代表的海内企业已经冲破了国外巨子常年垄断的局势,并且已经在海内 CMP市场霸占了主要份额。
公司已经实现28nm制程的成熟家当化运用,14nm制程工艺 技能正处于验证中;公司CMP产品在已量产的制程(14nm以上)及工艺运用中与 国外巨子的紧张产品不存在技能差距,在客户端线上已经可以实现对国外龙头产品 的替代。公司生产的CMP已经广泛运用于中芯国际、长江存储、华虹集团、大连 英特尔、厦门联芯、长鑫存储、广州粤芯、上海积塔等行业内领先的集成电路制造 企业的大生产线,霸占国产CMP发卖的绝大部分市场份额。
整体国产化率: 2018年海内CMP设备市场规模以及华海清科的 CMP设备发卖收入打算,2018-2020年华海清科在海内CMP市场的霸占率分别为 1.05%、6.15%、12.64%。
部分产线的国产化率达到20%乃至更高:统计了中国招标网上的几条晶圆厂 线(包括长江存储、华虹宏力、华力集成、积塔半导体、晶合集成)的中标结果, 华海清科2019-2020年的整体市场份额分别达到20.5%、35.3%。
家当链紧密互助,海内已经实现12英寸前辈产线上全国产CMP装备的打破。完成 CMP工艺除了CMP机台外,还须要抛光材料,紧张包括抛光液和抛光垫,这两者 占CMP材料的份额超过80%。根据华力微干系资料,2018年1月,华海清科的Cu&Si CMP 设备进入上海华力,标志着国产首台12英寸铜制程工艺CMP设备正式进入 集成电路大产线。目前,由上海华力牵头,形成了华海清科的CMP机台+鼎汇微电 子的研磨垫+安吉微电子的研磨液的国产CMP三合一模式,是环球首次12英寸前辈生产线上全国产CMP装备的攻关探索。
这次国产三合一路首选择层间介质研磨(ILD CMP)作为攻关点。ILD CMP通过 抛光SIO2介质层,达到指定厚度的平整层,以利于后续沉积金属互联线和光刻工 艺。由于ILD CMP研磨工具均是氧化硅,研磨垫和研磨液种类单一,工艺难点在于ILD CMP本身没有停滞层,必须通过精确掌握研磨韶光来达到指定的ILD厚度。 上海华力利用业内领先的前辈自动工艺掌握系统(I-APC)来实现厚度精准掌握, 已经成熟运用于上海华力量产工艺中,对付华海清科国产研磨机台也开拓了海内自 己的I-APC系统。
(三)干系公司
华海清科:天津华海清科机电科技有限公司成立于 2013 年,是天津市政府与清华 大学践行“京津冀一体化”国家计策,为推动我国化学机器抛光(CMP)技能和设备 家当化成立的高科技企业。公司紧张从事 CMP 设备和工艺及配套耗材的研发、 生产、发卖与做事,核心团队成员来自清华大学摩擦学国家重点实验室及业内专业 人才。根据公司招股解释书,华海清科作为目前海内唯一能供应12英寸CMP设备 的厂商,所产主流机型可实现28nm及以上成熟制程的家当化运用与国产替代,成 功冲破了国际巨子在CMP设备领域数十年的垄断,公司14nm制程仍处于客户验证 阶段。
2015 年起公司设备陆续进入海内产线进行设备验证,并从 2018 年开始逐步取得 批量采购订单,2019年公司订单及生产规模大幅增加。截至2020年底,累计出货 58台,在手订单35台,下贱客户覆盖中芯国际、长江存储、华虹集团、英特尔、 长鑫存储、上海积塔半导体等。2020年公司业务收入3.86亿元,三年CAGR172%, 毛净利率分别为38.2%和25.3%。
北京烁科:北京烁科精微电子装备有限公司是中国电子科技集团有限公司所属中电 科电子装备集团有限公司为实现科技成果转化设立的稠浊所有制公司,于2019年9 月23日注册成立。公司自主研发的CMP设备知足IC制造中所有繁芜平坦化工艺需 求(如IMD、STI、ILD、BPSG、contactor、metal line等,同时支持TSV、MEMS 等新领域的平坦化工艺),知足0.09-0.35um工艺节点集成电路生产须要,并涵盖8 英寸和12英寸产线。 2020年公司批量生产的HJP-200型CMP 设备已通过SEMI S2和SEMI F47认证,并通过中芯国际和华虹宏力的大产线家当化验证,进入合格供应商名单,形成批量采购。而12英寸(300mm)CMP设备也 于2020年11月进入工艺验证阶段。
在横向布局方面,公司正在建立集CMP设备、耗材、附属设备以及工艺demo于一 体的国产CMP成套工艺平台,供应一站式CMP技能办理方案,实现CMP成套技能 的国产化。此外,还将在集成电路平坦化技能领域开拓探索,对前沿的Finfet技能, Ru/Co等分外材料的平坦化工艺进行深入探索,不断推动下一代平坦化技能发展。
三、总结
CMP设备作为半导系统编制造过程中关键工艺制程设备之一,将持续受益下贱扩产以及国产替代进程。目前海内少数几家公司已经取得成熟制程领域打破, 冲破国外垄断局势,并且正逐步向前辈制程领域推进,在海内市场已经取得较高的 市场份额,未来有望进一步推进国产替代。
(本文仅供参考,不代表我们的任何投资建议。如需利用干系信息,请参阅报告原文。)
精选报告来源:【未来智库官网】。
「链接」















