①
繁芜繁琐的芯片设计流程

芯片制造的过程就犹如用乐高盖屋子一样,先有晶圆作为地基,再层层往上叠的芯片制造流程后,就可产出必要的 IC 芯片(这些会在后面先容)。然而,没有设计图,拥有再逼迫造能力都没有用,因此,建筑师的角色相称主要。但是 IC 设计中的建筑师究竟是谁呢?本文接下来要针对 IC 设计做先容。
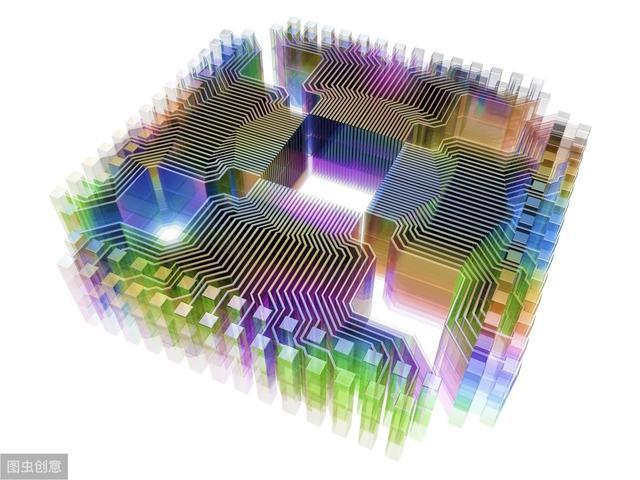
在 IC 生产流程中,IC 多由专业 IC 设计公司进行方案、设计,像是联发科、高通、Intel 等有名大厂,都自行设计各自的 IC 芯片,供应不同规格、效能的芯片给下贱厂商选择。由于 IC 是由各厂自行设计,以是 IC 设计十分仰赖工程师的技能,工程师的本色影响着一间企业的代价。然而,工程师们在设计一颗 IC 芯片时,究竟有那些步骤?设计流程可以大略分成如下。
设计第一步,订定目标
在 IC 设计中,最主要的步骤便是规格制订。这个步骤就像是在设计建筑前,先决定要几间房间、浴室,有什么建筑法规须要遵守,在确定好所有的功能之后在进行设计,这样才不用再花额外的韶光进行后续修正。IC 设计也须要经由类似的步骤,才能确保设计出来的芯片不会有任何差错。
规格制订的第一步便是确定 IC 的目的、效能为何,对大方向做设定。接着是察看有哪些协定要符合,像无线网卡的芯片就须要符合 IEEE 802.11 等规範,不然,这芯片将无法和市情上的产品相容,使它无法和其他设备连线。末了则是确立这颗 IC 的实作方法,将不同功能分配身分歧的单元,并确立不同单元间贯串衔接的方法,如此便完成规格的制订。
设计完规格后,接着便是设计芯片的细节了。这个步骤就像初步记下建筑的规画,将整体轮廓描述出来,方便后续制图。在 IC 芯片中,便是利用硬体描述措辞(HDL)将电路描写出来。常利用的 HDL 有 Verilog、VHDL 等,藉由程式码便可轻易地将一颗 IC 地功能表达出来。接着便是检讨程式功能的精确性并持续修正,直到它知足期望的功能为止。
▲ 32 bits 加法器的 Verilog 范例
有了电脑,事情都变得随意马虎
有了完全规画后,接下来便是画出平面的设计蓝图。在 IC 设计中,逻辑合成这个步骤便是将确定无误的 HDL code,放入电子设计自动化工具(EDA tool),让电脑将 HDL code 转换成逻辑电路,产生如下的电路图。之后,反覆的确定此逻辑闸设计图是否符合规格并修正,直到功能精确为止。
▲ 掌握单元合成后的结果
末了,将合成完的程式码再放入另一套 EDA tool,进行电路布局与绕线(Place And Route)。在经由不断的检测后,便会形成如下的电路图。图中可以看到蓝、红、绿、黄平分歧颜色,每种不同的颜色就代表着一张光罩。至于光罩究竟要如何利用呢?
▲ 常用的演算芯片- FFT 芯片,完成电路布局与绕线的结果
层层光罩,叠起一颗芯片
首先,目前已经知道一颗 IC 会产生多张的光罩,这些光罩有高下层的分别,每层有各自的任务。下图为大略的光罩例子,以积体电路中最基本的元件 CMOS 为範例,CMOS 全名为互补式金属氧化物半导体(Complementary metal–oxide–semiconductor),也便是将 NMOS 和 PMOS 两者做结合,形成 CMOS。至于什么是金属氧化物半导体(MOS)?这种在芯片中广泛利用的元件比较难解释,一样平常读者也较难弄清,在这裡就不多加细究。
下图中,左边便是经由电路布局与绕线后形成的电路图,在前面已经知道每种颜色便代表一张光罩。右边则是将每张光罩放开的样子。制作是,便由底层开始,依循上一篇 IC 芯片的制造中所提的方法,逐层制作,末了便会产生期望的芯片了。
至此,对付 IC 设计该当有初步的理解,整体看来就很清楚 IC 设计是一门非常繁芜的专业,也多亏了电脑赞助软体的成熟,让 IC 设计得以加速。IC 设计厂十分依赖工程师的聪慧,这裡所述的每个步骤都有其专门的知识,皆可独立成多门专业的课程,像是撰写硬体描述措辞就不纯挚的只须要熟习程式措辞,还须要理解逻辑电路是如何运作、如何将所需的演算法转换成程式、合成软体是如何将程式转换成逻辑闸等问题。
个中紧张半导体设计公司有英特尔、高通、博通、英伟达、美满、赛灵思、Altera、联发科、海思、展讯、复兴微电子、华大、大唐、智芯、敦泰、士兰、中星、格科等。
②
什么是晶圆?
在半导体的新闻中,总是会提到以尺寸标示的晶圆厂,如 8 寸或是 12 寸晶圆厂,然而,所谓的晶圆到底是什么东西?个中 8 寸指的是什么部分?要产出大尺寸的晶圆制造又有什么难度呢?以下将逐步先容半导体最主要的根本——「晶圆」到底是什么。
晶圆(wafer),是制造各式电脑芯片的根本。我们可以将芯片制造比拟成用乐高积木盖屋子,藉由一层又一层的堆叠,完本钱身期望的造型(也便是各式芯片)。然而,如果没有良好的地基,盖出来的屋子就会歪来歪去,不合自己所意,为了做出完美的屋子,便须要一个平稳的基板。对芯片制造来说,这个基板便是接下来将描述的晶圆。
(Souse:Flickr/Jonathan Stewart CC BY 2.0)
首先,先回忆一下小时候在玩乐高积木时,积木的表面都会有一个一个小小圆型的凸出物,藉由这个布局,我们可将两块积木稳固的叠在一起,且不需利用胶水。芯片制造,也因此类似这样的办法,将后续添加的原子和基板固定在一起。因此,我们须要探求表面整洁的基板,以知足后续制造所需的条件。
在固体材料中,有一种分外的晶体构造──单晶(Monocrystalline)。它具有原子一个接着一个紧密排列在一起的特性,可以形成一个平整的原子表层。因此,采取单晶做成晶圆,便可以知足以上的需求。然而,该如何产生这样的材料呢,紧张有二个步骤,分别为纯化以及拉晶,之后便能完成这样的材料。
如何制造单晶的晶圆
纯化分成两个阶段,第一步是冶金级纯化,此一过程紧张是加入碳,以氧化还原的办法,将氧化硅转换成 98% 以上纯度的硅。大部份的金属提炼,像是铁或铜等金属,皆是采取这样的办法得到足够纯度的金属。但是,98% 对付芯片制造来说依旧不足,仍须要进一步提升。因此,将再进一步采取西门子制程(Siemens process)作纯化,如此,将得到半导系统编制程所需的高纯度多晶硅。
▲ 硅柱制造流程(Source: Wikipedia)
接着,便是拉晶的步骤。首先,将前面所得到的高纯度多晶硅融化,形成液态的硅。之后,以单晶的硅种(seed)和液体表面打仗,一边旋转一边缓慢的向上拉起。至于为何必要单晶的硅种,是由于硅原子排列就和人排队一样,会须要排头让后来的人该如何精确的排列,硅种便是主要的排头,让后来的原子知道该如何排队。末了,待离开液面的硅原子凝固后,排列整洁的单晶硅柱便完成了。
▲ 单晶硅柱(Souse:Wikipedia)
然而,8寸、12寸又代表什么东西呢?他指的是我们产生的晶柱,长得像铅笔笔桿的部分,表面经由处理并切成薄圆片后的直径。至于制造大尺寸晶圆又有什么难度呢?如前面所说,晶柱的制作过程就像是在做棉花糖一样,一边旋转一边成型。有制作过棉花糖的话,该当都知道要做出大而且踏实的棉花糖是相称困难的,而拉晶的过程也是一样,旋转拉起的速率以及温度的掌握都会影响到晶柱的品质。也因此,尺寸愈大时,拉晶对速率与温度的哀求就更高,因此要做出高品质 12 寸晶圆的难度就比 8 寸晶圆还来得高。
只是,一整条的硅柱并无法做成芯片制造的基板,为了产生一片一片的硅晶圆,接着须要以钻石刀将硅晶柱横向切成圆片,圆片再经由抛光便可形成芯片制造所需的硅晶圆。经由这么多步骤,芯片基板的制造便大功告成,下一步便是堆叠屋子的步骤,也便是芯片制造。至于该如何制作芯片呢?
③
层层堆叠打造的芯片
在先容过硅晶圆是什么东西后,同时,也知道制造 IC 芯片就像是用乐高积木盖屋子一样,藉由一层又一层的堆叠,创造自己所期望的造型。然而,盖屋子有相称多的步骤,IC 制造也是一样,制造 IC 究竟有哪些步骤?本文将姑息 IC 芯片制造的流程做先容。
在开始前,我们要先认识 IC 芯片是什么。IC,全名积体电路(Integrated Circuit),由它的命名可知它是将设计好的电路,以堆叠的办法组合起来。藉由这个方法,我们可以减少连接电路时所需耗费的面积。下图为 IC 电路的 3D 图,从图中可以看出它的构培养像屋子的樑和柱,一层一层堆叠,这也便是为何会将 IC 制造比拟成盖屋子。
▲ IC 芯片的 3D 剖面图。(Source:Wikipedia)
从上图中 IC 芯片的 3D 剖面图来看,底部深蓝色的部分便是上一篇先容的晶圆,从这张图可以更明确的知道,晶圆基板在芯片中扮演的角色是何等主要。至于赤色以及土黄色的部分,则是于 IC 制作时要完成的地方。
首先,在这裡可以将赤色的部分比拟成高楼中的一楼大厅。一楼大厅,是一栋屋子的门户,出入都由这裡,在节制交通下常日会有较多的性能性。因此,和其他楼层比较,在兴建时会比较繁芜,须要较多的步骤。在 IC 电路中,这个大厅便是逻辑闸层,它是整颗 IC 中最主要的部分,藉由将多种逻辑闸组合在一起,完成功能完好的 IC 芯片。
黄色的部分,则像是一样平常的楼层。和一楼比较,不会有太繁芜的布局,而且每层楼在兴建时也不会有太多变革。这一层的目的,是将赤色部分的逻辑闸相连在一起。之以是须要这么多层,是由于有太多线路要贯串衔接在一起,在单层无法容纳所有的线路下,就要多叠几层来达成这个目标了。在这之中,不同层的线路会高下相连以知足接线的需求。
分层施工,逐层架构
知道 IC 的布局后,接下来要先容该如何制作。试想一下,如果要以油漆喷罐做风雅作图时,我们需先割出图形的遮盖板,盖在纸上。接着再将油漆均匀地喷在纸上,待油漆乾后,再将遮板拿开。不断的重复这个步骤后,便可完成整洁且繁芜的图形。制造 IC 便是以类似的办法,藉由遮盖的办法一层一层的堆叠起来。
制作 IC 时,可以大略分成以上 4 种步骤。虽然实际制造时,制造的步骤会有差异,利用的材料也有所不同,但是大体上皆采取类似的事理。这个流程和油漆作画有些许不同,IC 制造是先涂料再加做遮盖,油漆作画则是先遮盖再作画。以下将先容各流程。
金属溅镀:将欲利用的金属材料均匀洒在晶圆片上,形成一薄膜。涂布光阻:先将光阻材料放在晶圆片上,透过光罩(光罩事理留待下次解释),将光束打在不要的部分上,毁坏光阻材料构造。接着,再以化学药剂将被毁坏的材料洗去。蚀刻技能:将没有受光阻保护的硅晶圆,以离子束蚀刻。光阻去除:利用去光阻液皆剩下的光阻溶解掉,如此便完成一次流程。末了便会在一整片晶圆上完成很多 IC 芯片,接下来只要将完成的方形 IC 芯片剪下,便可送到封装厂做封装,至于封装厂是什么东西?就要待之后再做解释啰。
▲ 各种尺寸晶圆的比较。(Source:Wikipedia)
个中,紧张晶圆代工厂有格罗方德、三星电子、Tower Jazz、Dongbu、美格纳、IBM、富士通、英特尔、海力士、台积电、联电、中芯国际、力晶、华虹、德茂、武汉新芯、华微、华立、力芯。
④
纳米制程是什么?
三星以及台积电在前辈半导系统编制程打得相称火热,彼此都想要在晶圆代工中抢得先机以争取订单,险些成了 14 纳米与 16 纳米之争,然而 14 纳米与 16 纳米这两个数字的究竟意义为何,指的又是哪个部位?而在缩小制程后又将来带来什么好处与难题?以下我们姑息纳米制程做大略的解释。
纳米到底有多细微?
在开始之前,要先理解纳米究竟是什么意思。在数学上,纳米是 0.000000001 公尺,但这是个相称差的例子,毕竟我们只看得到小数点后有很多个零,却没有实际的觉得。如果以指甲厚度做比较的话,或许会比较明显。
用尺规实际丈量的话可以得知指甲的厚度约为 0.0001 公尺(0.1 毫米),也便是说试着把一片指甲的侧面切成 10 万条线,每条线就约等同于 1 纳米,由此可略为想像得到 1 纳米是何等的眇小了。
知道纳米有多小之后,还要理解缩小制程的用意,缩小电晶体的最紧张目的,便是可以在更小的芯片中塞入更多的电晶体,让芯片不会因技能提升而变得更大;其次,可以增加处理器的运算效率;再者,减少体积也可以降落耗电量;末了,芯片体积缩小后,更随意马虎塞入行动装置中,知足未来轻薄化的需求。
再回来探究纳米制程是什么,以 14 纳米为例,其制程是指在芯片中,线最小可以做到 14 纳米的尺寸,下图为传统电晶体的长相,以此作为例子。缩小电晶体的最紧张目的便是为了要减少耗电量,然而要缩小哪个部分才能达到这个目的?左下图中的 L 便是我们期望缩小的部分。藉由缩小闸极长度,电流可以用更短的路径从 Drain 端到 Source 端(有兴趣的话可以利用 Google 以 MOSFET 征采,会有更详细的阐明)。
(Source:http://www.slideshare.net)
此外,电脑因此 0 和 1 作运算,要如何以电晶体知足这个目的呢?做法便是判断电晶体是否有电流流利。当在 Gate 端(绿色的方块)做电压供给,电流就会从 Drain 端到 Source 端,如果没有供给电压,电流就不会流动,这样就可以表示 1 和 0。(至于为什么要用 0 和 1 作判断,有兴趣的话可以去查布林代数,我们是利用这个方法作成电脑的)
尺寸缩小有其物理限定
不过,制程并不能无限制的缩小,当我们将电晶体缩小到 20 纳米旁边时,就会碰着量子物理中的问题,让电晶体有泄电的征象,抵销缩小 L 时得到的效益。作为改进办法,便是导入 FinFET(Tri-Gate)这个观点,如右上图。在 Intel 以前所做的阐明中,可以知道藉由导入这个技能,能减少因物理征象所导致的泄电征象。
(Source:http://www.slideshare.net)
更主要的是,藉由这个方法可以增加 Gate 端和下层的打仗面积。在传统的做法中(左上图),打仗面只有一个平面,但是采取 FinFET(Tri-Gate)这个技能后,打仗面将变成立体,可以轻易的增加打仗面积,这样就可以在保持一样的打仗面积下让 Source-Drain 端变得更小,对缩小尺寸有相称大的帮助。
末了,则是为什么会有人说各大厂进入 10 纳米制程将面临相称严厉的寻衅,主因是 1 颗原子的大小大约为 0.1 纳米,在 10 纳米的情形下,一条线只有不到 100 颗原子,在制作上相称困难,而且只要有一个原子的毛病,像是在制作过程中有原子掉出或是有杂质,就会产生不有名的征象,影响产品的良率。
如果无法想像这个难度,可以做个小实验。在桌上用 100 个小珠子排成一个 10×10 的正方形,并且剪裁一张纸盖在珠子上,接着用小刷子把阁下的的珠子刷掉,末了使他形成一个 10×5 的长方形。这样就可以知道各大厂所面临到的困境,以及达成这个目标究竟是多么艰巨。
随着三星以及台积电在近期将完成 14 纳米、16 纳米 FinFET 的量产,两者都想争夺 Apple 下一代的 iPhone 芯片代工,我们将看到相称精彩的商业竞争,同时也将得到更加省电、轻薄的手机,要感谢摩尔定律所带来的好处呢。
⑤
见告你什么是封装
经由漫长的流程,从设计到制造,终于得到一颗 IC 芯片了。然而一颗芯片相称小且薄,如果不在外施加保护,会被轻易的刮伤破坏。此外,由于芯片的尺寸眇小,如果不用一个较大尺寸的外壳,将不易以人工安置在电路板上。因此,本文接下来要针对封装加以描述先容。
目前常见的封装有两种,一种是电动玩具内常见的,玄色长得像蜈蚣的 DIP 封装,另一为购买盒装 CPU 时常见的 BGA 封装。至于其他的封装法,还有早期 CPU 利用的 PGA(Pin Grid Array;Pin Grid Array)或是 DIP 的改良版 QFP(塑料方形扁平封装)等。由于有太多种封装法,以下将对 DIP 以及 BGA 封装做先容。
传统封装,经久不衰
首先要先容的是双排直立式封装(Dual Inline Package;DIP),从下图可以看到采取此封装的 IC 芯片在双排接脚下,看起来会像条玄色蜈蚣,让人印象深刻,此封装法为最早采取的 IC 封装技能,具有本钱低廉的上风,适宜小型且不需接太多线的芯片。但是,由于大多采取的是塑料,散热效果较差,无法知足现行高速芯片的哀求。因此,利用此封装的,大多是经久不衰的芯片,如下图中的 OP741,或是对运作速率没那么哀求且芯片较小、接孔较少的 IC 芯片。
▲ 左图的 IC 芯片为 OP741,是常见的电压放大器。右图为它的剖面图,这个封装因此金线将芯片接到金属接脚(Leadframe)。(Source :左图 Wikipedia、右图 Wikipedia)
至于球格阵列(Ball Grid Array,BGA)封装,和 DIP 比较封装体积较小,可轻易的放入体积较小的装置中。此外,由于接脚位在芯片下方,和 DIP 比较,可容纳更多的金属接脚
相称适宜须要较多接点的芯片。然而,采取这种封装法本钱较高且连接的方法较繁芜,因此大多用在高单价的产品上。
▲ 左图为采取 BGA 封装的芯片。右图为利用覆晶封装的 BGA 示意图。(Source: 左图 Wikipedia)
行动装置兴起,新技能跃上舞台
然而,利用以上这些封装法,会耗费掉相称大的体积。像现在的行动装置、穿着装置等,须要相称多种元件,如果各个元件都独立封装,组合起来将耗费非常大的空间,因此目前有两种方法,可知足缩小体积的哀求,分别为 SoC(System On Chip)以及 SiP(System In Packet)。
在聪慧型手机刚兴起时,在各大财经杂誌上皆可创造 SoC 这个名词,然而 SoC 究竟是什么东西?大略来说,便是将原来不同功能的 IC,整合在一颗芯片中。藉由这个方法,不单可以缩小体积,还可以缩小不同 IC 间的间隔,提升芯片的打算速率。至于制作方法,便是在 IC 设计阶段时,将各个不同的 IC 放在一起,再透过先前先容的设计流程,制作成一张光罩。
然而,SoC 并非只有优点,要设计一颗 SoC 须要相称多的技能合营。IC 芯片各自封装时,各有封装外部保护,且 IC 与 IC 间的间隔较远,比较不会发生交互滋扰的环境。但是,当将所有 IC 都包装在一起时,便是噩梦的开始。IC 设计厂要从原来的纯挚设计 IC,变成理解并整合各个功能的 IC,增加工程师的事情量。此外,也会碰着很多的状况,像是通讯芯片的高频讯号可能会影响其他功能的 IC 等环境。
此外,SoC 还须要得到其他厂商的 IP(intellectual property)授权,才能将别人设计好的元件放到 SoC 中。由于制作 SoC 须要得到整颗 IC 的设计细节,才能做成完全的光罩,这同时也增加了 SoC 的设计本钱。或许会有人质疑何不自己设计一颗就好了呢?由于设计各种 IC 须要大量和该 IC 干系的知识,只有像 Apple 这样多金的企业,才有预算能从各有名企业挖角顶尖工程师,以设计一颗全新的 IC,透过互助授权还是比自行研发划算多了。
折衷方案,SiP 现身
作为替代方案,SiP 跃上整合芯片的舞台。和 SoC 不同,它是购买各家的 IC,在末了一次封装这些 IC,如此便少了 IP 授权这一步,大幅减少设计本钱。此外,由于它们是各自独立的 IC,彼此的滋扰程度大幅低落。
▲ Apple Watch 采取 SiP 技能将全体电脑架构封装成一颗芯片,不单知足期望的效能还缩小体积,让手錶有更多的空间放电池。(Source:Apple 官网)
采取 SiP 技能的产品,最着名的非 Apple Watch 莫属。由于 Watch 的内部空间太小,它无法采取传统的技能,SoC 的设计本钱又太高,SiP 成了紧张之选。藉由 SiP 技能,不单可缩小体积,还可拉近各个 IC 间的间隔,成为可行的折衷方案。下图便是 Apple Watch 芯片的构造图,可以看到相称多的 IC 包含在个中。
▲ Apple Watch 中采取 SiP 封装的 S1 芯片内部配置图。(Source:chipworks)
完成封装后,便要进入测试的阶段,在这个阶段便要确认封装完的 IC 是否有正常的运作,精确无误之后便可出货给组装厂,做成我们所见的电子产品。个中紧张的半导体封装与测试企业有安靠、星科金朋、J-devices、Unisem、Nepes、日月光、力成、南茂、颀邦、京元电子、福懋、菱生精密、矽品、长电、优特.
至此,半导体家当便完成了全体生产的任务。
来源:闲话历史01












