Dry Etch的机理:先在低压的反应室内导入气体,然后通过射频能量将气体引发成等离子体,再利用等离子体的与晶圆表面进行化学反应和物理反应,来进行薄膜刻蚀,去除部分材质,留下所须要的构造;
特点:紧张为等离子体(含有高活性自由基和离子)进行刻蚀,等离子体含有一定的动能,且个中的自由基具有强烈的氧化性。

工艺上紧张有三类运用:介质刻蚀,单、多晶硅刻蚀,金属刻蚀
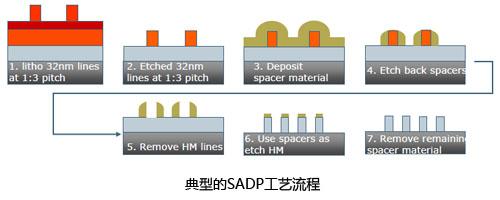
A.介质刻蚀
特点:紧张利用损伤机理,个中物理反应比化学反应多。RF power 较高,压力较低。氧化物刻蚀的紧张运用
1.掺杂或没掺杂的硅酸盐玻璃2.打仗孔 (PSG/BPSG)3.过孔 (USG/FSG/Low-K 介质)氮化物刻蚀的紧张运用
1.LOCOS (LPCVD SiN)2.压焊点 (PECVD SiN)干系的化学反应如下:
B.单、多晶硅刻蚀
特点:紧张利用保护机理, 化学反应比物理反应起更大浸染单晶硅紧张运用:
1.浅槽的隔离 (STI)形成。2.深槽电容的天生。3.采取硬掩膜(氮化硅/氧化硅),由于光刻胶可能引起衬底玷污。多晶硅紧张运用:
1.栅电极的形成(最主要的刻蚀),最小CD.2. 多晶硅的局部互连。3. DRAM电容电极的形成。单晶硅的化学反应如下:
多晶硅的化学反应如下:
C.金属刻蚀
特点:与硅刻蚀类似,紧张利用保护机理,化学反应比物理反应起更大浸染。目的:形成金属布线和互连。适宜的金属种类:Al(Cu、Si合金),W,Ti和TiN,金属硅化物等。干系的化学反应如下:点击上方“芯小虎”关注我,分享更多的芯片知识和新闻!
如果喜好,请"点赞"+"收藏",感激!














