热阻是衡量超高亮度和功率型LED器件及阵列组件热工掌握设计是否合理的一个最关键的参数。
丈量芯片热阻的紧张方法有:电学参数法和红外热像法。个中电学法利用LED本身的热敏感参数——电压变革来反算出温升,从而得到事情状态下的结温,是LED器件及运用产品热工参数丈量中最常利用的方法。而红外热像法是红外探测器通过光学成像物镜吸收被测目标的红外辐射能量,并把能量分布反响到红外探测器的光敏组件上,从而得到红外热像图,这种热图像与物体表面的热分布场相对应。

然而电学法是间接测试方法,只能丈量出单点的温度,无法对LED整体温度场分布加以丈量评价,再加上其丈量精度不足,操作繁芜等,难以在生产实践中推广。电学参数法是间接测试芯片结温的方法,很多人想知道其测试的准确性,与红外热像测试数据是否能对应,灌封封装后的胶面温度和灯珠结温之间又有着若何的关系。本文就此做详细磋商。
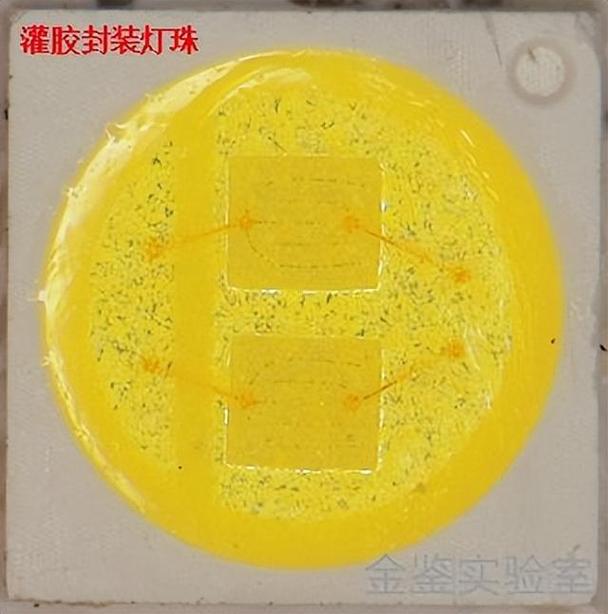
测试样品
金鉴测试样品为同一批次的两颗3030灯珠,一颗为灌胶封装的灯珠,封装胶中带有荧光粉;另一颗为未灌胶封装的灯珠。该灯珠额定电流为300mA,在实际利用时灯珠基板底部温度为50.0℃。
测试仪器
金鉴自主研发的显微光分布测试系统配备有20um的微距镜,可用于不雅观察芯片微米级别的红外热分布;通过软件算法处理,图像的分辨率改进至5um,能看清芯片金道;该系统还配备有高低温精密控温平台,能仿照芯片实际事情温度进行测试,供应的数据更为真实有效;通过软件分区域校正发射率,可达到精准测温度的目的。
金鉴显微热分布测试系统(GMATG G4)
热瞬态测试仪(T3ster)
测试流程
未灌胶灯珠芯片热分布测试
金鉴工程师利用显微热分布测试系统在暗室中对未灌胶灯珠的芯片表面进行热分布测试,测试结果如下:
(1). 将灯珠在100℃控温台上加热达到稳定后,测得灯珠芯片ITO层的发射率为0.77,芯片金道的发射率为0.67。
(2). 在300mA下将未灌胶灯珠通电点亮,调节控温台温度,使灯珠基板底部温度稳定在50.0℃,此时灯珠负极引脚温度为53.9℃,利用显微热分布测试系统测试灯珠芯片表面温度,设置不同区域的发射率,所得灯珠芯片表面温度及热分布数据如图所示。芯片表面温度约为62.4℃~66.1℃。
未灌胶灯珠芯片表面热分布图
电学法测试灌胶封装灯珠芯片结温
金鉴工程师根据该款灯珠实际利用时的参数,设置驱动电流为300mA,掌握灯珠基板底部温度为50.0℃,此时控温槽温度Tc为50.0℃,下表为该条件下所测得的结果:
(1). 灯珠热阻为灯珠芯片PN结到灯珠支架底面的热阻之和。
(2). 本次热阻为扣除光功率的热阻值,光功率为在环境温度25℃下测得。
(3). 样品结温Tj=Tc+ΔT,为69.81℃;
灌胶封装灯珠热阻曲线图
灌胶封装灯珠胶面热分布测试
金鉴工程师利用显微热分布测试系统在暗室中对灯珠封装胶表面进行热分布测试,测试结果如下:
(1). 将灯珠在100℃控温台上加热达到稳定后,测得灯珠封装胶表面的发射率为0.97。
(2). 在300mA下将灯珠通电点亮,调节控温台温度,使灯珠基板底部温度稳定在50.0℃,此时灯珠负极引脚温度为58.2℃,利用显微热分布测试系统测试灯珠胶面温度,设置不同区域的发射率,所得灯珠胶面温度及胶面热分布数据如图所示。灯珠胶面温度约为77.8℃。
灌胶封装灯珠胶面热分布图
剖析结果
测试结果如下表所示:
测试样品
温度
未灌胶灯珠芯片表面温度(红外热像法)
62.4~66.1℃
灌胶灯珠芯片结温(电学法)
69.81 ℃
灌胶封装灯珠胶面温度(红外热像法)
77.8 ℃
(1). 灌胶灯珠芯片结温高于未灌胶灯珠芯片结温
该灯珠封装胶中配有荧光粉,荧光粉在被引发时会涌现自发热征象,使得灌胶封装灯珠的芯片结温升高。红外热像法和电学法所测数据相对应,符合实际情形,解释该两种芯片结温测试方法准确性较高。
(2). 灯珠胶面温度高于芯片结温
胶面热量紧张来源于芯片发热传导,还有一部分是荧光粉在受到引发时产生的热量。芯片产生的热量可通过支架、基板等导热性好的部件传导出去,而硅胶是不良导热体,热量向空气中传导更加困难,使得芯片和荧光粉向上传导的热在硅胶表面聚拢,涌现胶面温度大于结温的情形。
(3). 灌胶配粉的灯珠胶面和芯片结温会更高
当LED蓝光照射到荧光粉上时,一部分被反射、散射、透射,剩下的被接管,而被接管的这部分光中,一些作为发光跃迁,发射光子,一些作为晶格振动,产生猝灭,从而使得荧光粉产生了热量。荧光粉的自发热征象,会提高灯珠结温及胶面温度。












